3.2. Собственные (чистые) полупроводники
3.4. Электропроводность полупроводников
3.5. Воздействие внешних факторов на электропроводность полупроводников
3.5.1. Влияние температуры на электропроводность полупроводников
3.5.2. Влияние деформации на электропроводность полупроводников
3.5.3. Влияние света на электропроводность полупроводников
3.5.4. Влияние сильных электрических полей на электропроводность полупроводников
3.9. Полупроводниковые соединения типа АIIIВV
3.1. Общие сведения
Все полупроводниковые материалы делятся на простые полупроводники (ПП) или элементы, полупроводниковые химические соединения и полупроводниковые комплексы. В последнее время также изучаются стеклообразные и жидкие полупроводники. Простых ПП существует околодесяти. В современной технике особое значение приобрели кремний (Si), германий (Ge) и, частично, селен (Se).
|
Материалы |
Атомный № |
D W, эВ |
Подвижн. электронов, см2/В* с |
Подвижн. дырок, см2/В* с |
|
Ge |
32 |
0.67 |
3900 |
1900 |
|
Si |
14 |
1.12 |
1400 |
500 |
| Se |
34 |
1.79 |
- |
0.2* 10-4 |
Полупроводниковыми химическими соединениями являются соединения элементов различных групп таблицы Менделеева, соответствующие общим формулам АIIВVI (CdS, ZnSe), АIIIВV(InSb, GaAs, GaP ), АIVВVI (PbS, PbSe, PbTe), также некоторые оксиды и вещества сложного состава.
AIII BV
| Материалы |
D W, эВ |
Подвижн. электронов, см2/В* с |
Подвижн. дырок, см2/В* с |
|
GaSb |
0.7 |
5000 |
800 |
|
InSb |
0.18 |
80000 |
1000 |
| GaAs |
1.4 |
8500 |
400 |
| InAs |
0.35 |
30000 |
500 |
AII BVI
| Материалы |
D W, эВ |
Подвижн. электронов ,с см2/В* с |
Подвижн. дырок, см2/В* с |
|
ZnS |
3.74 |
140 |
5 |
|
CdS |
2.53 |
340 |
110 |
| HgS |
1.78 |
700 |
- |
| ZnSe |
2.73 |
260 |
15 |
AIVBVI
| Материалы |
D W, эВ |
Подвижн. электронов, см2/В* с |
Подвижн. дырок, См2/В* с |
|
PbS |
0.39 |
600 |
700 |
|
CdS |
0.27 |
1200 |
1000 |
| HgS |
0.32 |
1800 |
900 |
К полупроводниковым комплексам можно отнести вещества с полупроводящей или проводящей фазой и карбида кремния, графита, сцепленных керамической или другой связкой. Наиболее распространенными из них являются тирит, силит и др. c шириной запрещенной зоны 0.75 ч 1.35 эВ.
3.2. Собственные (чистые) полупроводники
На внешней оболочке атомов простых полупроводников имеется четыре валентных электрона. Когда атомы связываются в кристаллическую решетку, эти электроны становятся общими для ближайших четырех атомов, такая связь называется ковалентной.
 Рис. 3.1. Кристаллическая решетка собственного полупроводника
Рис. 3.1. Кристаллическая решетка собственного полупроводника
В невозбужденном состоянии свободных электронов нет. Но при внешнем энергетическом воздействии какому-либо электрону сообщается дополнительная энергия, он отрывается от атома и начинает свободно перемещаться по кристаллу. Но при этом на его месте образуется электронная дырка. Т.о. процесс генерации носителей в собственном полупроводнике – образование электронно-дырочной пары. А процесс исчезновения этой пары, т.е., когда дырка встречается с электроном – рекомбинация.
Дырки и электроны, образованные в процессе генерации, есть собственные носители зарядов ni , pi
3.2.1. Концентрация собственных носителей заряда
Так как при каждом акте возбуждения в собственном полупроводнике одновременно образуются два заряда, противоположных по знаку, то общее количество носителей будет в два раза больше числа электронов в зоне проводимости, т.е.
noi = poi, noi + poi = 2 noi (3.1)
В результате процессов генерации и рекомбинации при любой температуре тела устанавливается равновесная концентрация возбужденных носителей:
электронов
noi = 2Ncexp( ![]() ) (3.2)
) (3.2)
дырок
poi = 2NBexp(![]() ) (3.3)
) (3.3)
D W - ширина запрещенной зоны полупроводника, Nc - эффективная плотность состояния (число энергетических уровней в единице объема ПП) в свободной зоне, NB - то же в валентной зоне. Коэффициент 2 показывает, что на каждом уровне могут находиться по два электрона с противоположными спинами. ![]() - постоянная Больцмана.
- постоянная Больцмана.
В случае собственной электропроводности
ni = pi, но Jn > Jp
т.к. подвижность электрона больше подвижности дырки. А подвижность µ есть отношение скорости перемещения носителя к напряженности электрического поля в ПП:
m =![]() (3.4)
(3.4)
Следовательно, в поле кристаллической решетки электроны и дырки обладают различной инерционностью, т.е. отличаются друг от друга эффективными массами. В большинстве случаев, следовательно, собственная электропроводность полупроводника имеет слабо преобладающий электронный характер.
3.3. Примесные полупроводники
Для большинства полупроводниковых приборов используются примесные полупроводники. Поэтому в практике важное значение имеют такие полупроводниковые материалы, у которых ощутимая концентрация собственных носителей заряда наблюдается при достаточно высокой температуре, т.е. с большой шириной запрещенной зоны. Поставщиками свободных носителей зарядов в рабочем интервале температур в таких ПП являются примеси.
Примесями в простых полупроводниках являются чужеродные атомы. В химических же соединениях это не только чужеродные атомы, но и атомы тех самых элементов, избыточные по стехиометрическому составу. Кроме того, роль примесей играют дефекты кристаллической решетки.
Рассмотрим роль примесей, атомы которых создают дискретные энергетические уровни в запрещенной зоне полупроводника.
3.3.1. Донорные примеси
Если в кристаллическую решетку IV валентного элемента ввести атом элемента с валентностью V, то четыре электрона на его внешней оболочке свяжутся с четырьмя атомами IV валентного элемента, а один электрон становится избыточным, слабосвязанным со своим атомом. Он под вличнием тепловой энергии начнет свободно блуждать по полупроводнику, а под воздействием электрического поля он станет направленно перемещаться (электропроводность типа n ), а атом, отдавший электрон, будет неподвижно находиться в данном месте решетки полупроводника.
 Рис. 3.2 Схематическое изображение кристаллической решетки Ge с донорной примесью мышьяка.
Рис. 3.2 Схематическое изображение кристаллической решетки Ge с донорной примесью мышьяка.
С точки зрения энергетических диаграмм донорные примеси образуют заполненные энергетические уровни в запрещенной зоне вблизи дна зоны проводимости. При этом энергия активации примесных атомов меньше ширины запрещенной зоны, поэтому при нагреве тела переброс электронов примеси будет опережать возбуждение электронов решетки.
 Рис. 3.3. Энергетическая диаграмма донорного полупроводника.
Рис. 3.3. Энергетическая диаграмма донорного полупроводника.
3.3.2. Акцепторные примеси
Если в решетку IV валентного полупроводника ввести III элемент, например, бор, то он установит три ковалентные связи с атомами германия, для связи с четвертым атомом германия у атома бора нет электрона. Таким образом, у нескольких атомов германия будет по одному электрону без ковалентной связи. Достаточно теперь небольших внешних воздействий, чтобы эти электроны покинули свои места, образовав дырки у атомов германия. Освободившиеся электроны, захваченные атомами бора, не могут создать электрический ток. А дырки у атомов германия позволяют электронам с соседних атомов перейти на них, освобождая другие дырки. Т.о., положительно заряженная дырка будет перемещаться по кристаллу, а под действием поля возникает примесный дырочный ток.
 Рис. 3.4. Схематическое изображение кристаллической решетки Ge с акцепторной примесью In.
Рис. 3.4. Схематическое изображение кристаллической решетки Ge с акцепторной примесью In.
С точки зрения зонной теории, акцепторная примесь образует незаполненные энергетические уровни в запрещенной зоне вблизи потолка валентной зоны. Тепловое возбуждение будет в первую очередь перебрасывать электроны из валентной зоны на эти энергетические уровни. Ввиду разобщенности атомов примеси, электроны, заброшенные на примесные уровни, не участвуют в образовании электрического тока. Такой полупроводник будет иметь концентрацию дырок, большую концентрации электронов, перешедших из валентной зоны в зону проводимости. И его относят к полупроводнику p-типа.
 Рис. 3.5. Энергетическая диаграмма акцепторного полупроводника.
Рис. 3.5. Энергетическая диаграмма акцепторного полупроводника.
3.3.3. Основные и неосновные носители зарядов
Те носители, концентрация которых в данном полупроводнике больше, носят название основных, а те, которых меньше – неосновных. Так, в полупроводнике n-типа электроны являются основными носителями зарядов, а дырки – неосновными (nn и pn соответственно). Концентрация свободных электронов в зоне проводимости может быть различной. В большинстве случаев используются слаболегированные полупроводники; электроны в этом случае заполняют незначительную часть уровней в зоне проводимости. Такое состояние называют невырожденным. В полупроводнике p-типа основные носители – дырки (pp), а неосновные – электроны (np). Примесная электропроводность для своего появления требует меньших энергетических воздействий (сотые или десятые доли электронвольта), чем собственная, поэтому она обнаруживается при более низкой температуре, чем собственная электропроводность полупроводника. В примесном полупроводнике при данной температуре справедливо соотношение:
p·n = ni2 (3.5)
При нормальной температуре можно считать, что все примеси ионизированы. Тогда, например, в электронном полупроводнике концентрация основных носителей:
nn » Nд, а pn » ni2/Nд
а в дырочном:
pp » Na, a np » ni2/Na.
3.4. Электропроводность полупроводников
Полупроводник, не содержащий примесей, в нормальных условиях обладает так называемой собственной проводимостью или проводимостью типа i. Собственная проводимость обусловлена генерацией пар "электрон-дырка" . Если концентрация электронов в зоне проводимости – ni , а дырок в валентной зоне – pi и ni = pi,то собственная проводимость полупроводника:
σi = ni е (μn + μp) (3.6)
В примесном полупроводнике np, поэтому электропроводность выражается следующей формулой:
σ = е (μnn + μpp) (3.7)
3.5. Воздействие внешних факторов на электропроводность полупроводников
3.5.1. Влияние температуры на электропроводность полупроводников
В широком диапазоне температур и для различного содержания примесей имеют место температурные зависимости концентрации носителей заряда в полупроводнике n-типа, изображенные на рис. 3.6.
 Рис.3.6. Типичные зависимости концентрации носителей заряда в полупроводнике от температуры при различной концентрации донорной примеси
Рис.3.6. Типичные зависимости концентрации носителей заряда в полупроводнике от температуры при различной концентрации донорной примеси
В области низких температур участок нижней ломаной между точками а и б характеризует только концентрацию носителей, обусловленную примесями. Наклон прямой на этом участке определяется энергией активации примесей. С увеличением температуры число носителей, поставляемых примесями, возрастает, пока не истощатся электронные ресурсы примесных атомов (точка б). На участке б – в примеси уже истощены, перехода электронов через запрещенную зону еще не обнаруживается. Участок кривой с постоянной концентрацией носителей заряда называют областью истощения примесей. В дальнейшем температура настолько велика, что начинается быстрый рост концентрации носителей вследствие перехода электронов через запрещенную зону ( участок в – и). Наклон этого участка характеризует ширину запрещенной зоны полупроводника. Угол наклона участка а – б зависит от концентрации примесей.
Вторая компонента, обуславливающая электропроводность полупроводников – подвижность носителей заряда. При повышении температуры энергия электронов, а следовательно, и подвижность увеличивается. Но, начиная с некоторой температуры Т усиливаются колебания узлов кристаллической решетки полупроводника, которые мешают перемещению свободных носителей зарядов. Следовательно, их подвижность падает (рис.3.7.).
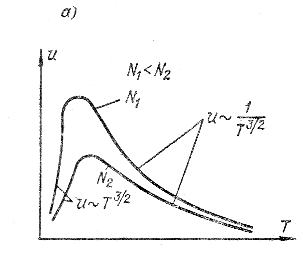 Рис.3.7. Зависимость подвижности носителей заряда в полупроводниках от температуры.
Рис.3.7. Зависимость подвижности носителей заряда в полупроводниках от температуры.
Рассмотрев влияние температуры на концентрацию и подвижность носителей заряда, можно представить и характер изменения удельной проводимости при изменении температуры (рис.3.8).
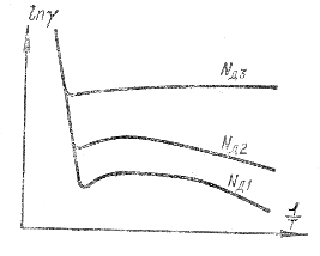 Рис.3.8. Кривые зависимости удельной проводимости полупроводников от температуры при различных концентрациях примеси (NД1>NД2>NД3).
Рис.3.8. Кривые зависимости удельной проводимости полупроводников от температуры при различных концентрациях примеси (NД1>NД2>NД3).
В ПП с атомной и ионной кристаллической решеткой подвижность меняется при изменении температуры сравнительно слабо ( по степенному закону), а концентрации – очень сильно ( по экспоненциальному ). Поэтому температурная зависимость удельной проводимости похожа на температурную зависимость концентрации. В области истощения (концентрация постоянна) изменение удельной проводимости обусловлено температурной зависимостью подвижности (рис.3.8).
При Т=0К электроны не обладают подвижностью, поэтому ПП становятся диэлектриками.
3.5.2. Влияние деформации на электропроводность полупроводника
Электропроводность твердых кристаллических тел изменяется от деформации вследствие увеличения или уменьшения межатомных расстояний, приводящего к изменению концентрации и подвижности носителей зарядов. Подвижность носителей изменяется из-за изменения амплитуды колебания узлов кристаллической решетки при их сближении или удалении.
Величиной, численно характеризующей изменение удельной проводимости полупроводников при определенном виде деформации, является тензочувствительность:
 (3.8)
(3.8)
которая представляет собой отношение относительного изменения удельного сопротивления полупроводника к относительной деформации в данном направлении.
3.5.3. Влияние света на электропроводность полупроводника
Световая энергия, поглощаемая полупроводником, вызывает появление в нем избыточного (по сравнению с равновесным при данной температуре) количества носителей зарядов, приводящего к возрастанию электропроводности.
Фотопроводимостью называют увеличение электрической проводимости вещества под действием электромагнитного излучения.
Изменение электрических свойств полупроводника под действием электромагнитного излучения носит временный характер. После прекращения облучения проводимость более или менее быстро возвращается к тому значению, которое она имела до облучения. У одних полупроводников это длится микросекунды, у других измеряется минутами и, даже, часами. Знание инерционности фотопроводимости различных полупроводниковых веществ важно при разработке, например, фоторезисторов, к которым предъявляются высокие требования в отношении их быстродействия.
Кроме того, по быстроте возрастания или затухания фотопроводимости соответственно после включения или выключения света, можно определить время жизни t 0 неравновесных носителей заряд в ПП.
Когда мы рассматривали концентрацию носителей заряда в примесном полупроводнике, мы имели в виду равновесную концентрацию, т.е. когда число свободных носителей заряда равно числу ионов примеси.
Под действием различных энергетических воздействий может возникнуть неравновесная концентрация зарядов, т.е. образование дополнительных электронно-дырочных пар. После прекращения этого воздействия электроны и дырки рекомбинируют, и концентрация вновь становится равновесной.
Процесс рекомбинации электронов и дырок может происходить либо прямым путем из зоны в зону, либо косвенным, через локальные энергетические уровни в запрещенной зоне, называемые центрами рекомбинации или ловушками, либо косвенным, через локальные энергетические уровни в запрещенной зоне, называемые центрами рекомбинации или ловушками.
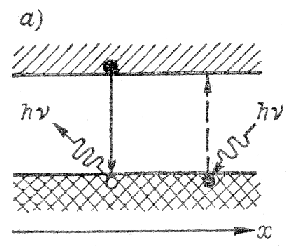 Рис. 3.9. Прямая рекомбинация и рекомбинация (а),
Рис. 3.9. Прямая рекомбинация и рекомбинация (а),
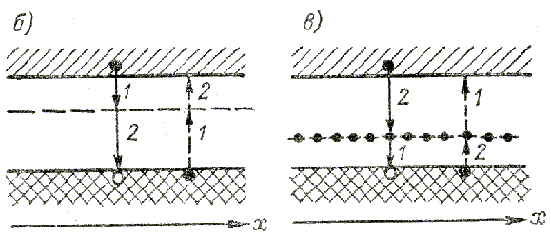 Рис. 3.9. Косвенная рекомбинация, через незаполненные уровни примеси б) и заполненные в).
Рис. 3.9. Косвенная рекомбинация, через незаполненные уровни примеси б) и заполненные в).
Второй механизм рекомбинации более вероятен, т.к. здесь движется только один носитель заряда, и вероятность сближения их на расстояние, при котором возможна рекомбинация (» 0,1 нм), значительно выше, чем в случае, когда оба носителя заряда перемещаются по кристаллу.
Ловушки создаются примесями, имеющими энергетические уровни вблизи середины запрещенной зоны полупроводника. Это медь, никель, кобальт, золото. Дефекты решетки, донорные и акцепторные примеси также могут создавать центры рекомбинации.
Итак, время жизни неравновесных носителей зарядов t 0 – время, за которое концентрация их в полупроводнике убывает в 2.7 раза.
Расстояние, на котором в однородном полупроводнике при одномерной диффузии в отсутствие электрического и магнитного полей избыточная концентрация неравновесных носителей уменьшится в 2.7 раза, т.е. среднее расстояние, на которое носители диффундировали за время жизни, называется диффузионной длиной.
Решая уравнение диффузии, можно получить выражение, связывающее диффузионную длину с временем жизни:
Ln = √Dn× tn , Lp = √ Dp· tp (3.9)
где D – коэффициент диффузии носителей заряда соответствующего типа.
3.5.4. Влияние сильных электрических полей на электропроводность полупроводников
В сильных электрических полях нарушается пропорциональность между плотностью тока в полупроводнике и напряженностью внешнего электрического поля:
J = γ× E, (3.10)
где J – плотность тока, γ- коэффициент пропорциональности, Е- напряженность внешнего электрического поля.
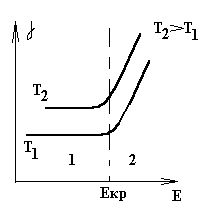 Рис. 3.10. Зависимость электропроводности от напряжения электрического поля.
Рис. 3.10. Зависимость электропроводности от напряжения электрического поля.
Это является следствием физических процессов, вызывающих изменение удельной проводимости полупроводника. Напряженность поля, которую условно можно принять за границу между областью слабых 1 и сильных 2 полей (рис. 3.10.), называют критической Екр. Эта граница не является резкой и определенной и зависит от природы полупроводника, концентрации примесей и температуры окружающей среды. Для ряда ПП зависимость удельной проводимости от напряженности поля описывается выражением:
γЕ = γ× exp b √Е (3.11)
где γ- удельная проводимость полупроводника при Е< Екр, b - коэффициент, характеризующий полупроводник.
Возрастание проводимости обусловлено ростом числа носителей заряда, т.к. под влиянием поля они более легко освобождаются тепловым возбуждением. При дальнейшем росте поля может появиться механизм ударной ионизации, приводящий к разрушению структуры полупроводника.
3.6. Токи в полупроводниках
3.6.1. Дрейфовый ток
Электроны и дырки в кристалле находятся в состоянии хаотического теплового движения. При возникновении электрического поля на хаотическое движение накладывается компонента направленного движения, обусловленная действием этого поля. В результате электроны и дырки начинают перемещаться вдоль кристалла – возникает электрический ток, который называют дрейфовым.
 Рис. 3.12. Перемещение заряженных частиц под действием электрического поля в полупроводнике
Рис. 3.12. Перемещение заряженных частиц под действием электрического поля в полупроводнике
3.6.2. Диффузионный ток
Причиной, вызывающей ток в полупроводнике, может быть не только электрическое поле, но и градиент концентрации подвижных носителей заряда.
Если тело электрически нейтрально и в любой его микрообласти суммарный положительный и отрицательный заряд равен нулю, то различие в концентрациях носителей заряда в соседних областях не приведет к появлению электрического тока и электрических сил расталкивания, выравнивающих концентрацию. Но в соответствии с общими законами теплового движения возникнет диффузия микрочастиц из области с большей их концентрацией в область с меньшей, причем плотность диффузионного тока пропорциональна градиенту концентрации носителей заряда:
Jp диф = - е Dp dp/dx, (3.11)
Где Dp – коэффициент диффузии дырок, dp/dx – градиент концентрации дырок, "-" - указывает, что диффузионный дырочный ток направлен в сторону уменьшения концентрации дырок.
Jn диф = e Dn dn/dx. (3.12)
Отсутствие минуса говорит лишь о том, что направление электрического тока, принятого в электротехнике, противоположно направлению потока электронов, а этот поток также движется в сторону уменьшения концентрации.
В общем случае в полупроводнике могут существовать и электрическое поле, и градиент концентрации носителей заряда. Тогда ток в полупроводнике будет иметь как дрейфовую, так и диффузионную составляющие.
3.7. Германий
Существование и основные свойства германия проедсказал в 1870г Д.И.Менделеев, назвав его экосилицием. В 1886г немецкий химик Винклер обнаружил в минеральном сырье новый элемент, который назвал германием. Германий оказался тождественным экосилицию. Открытие германия явилось торжеством Периодического закона Д.И.Менделеева.
Германий относится к числу сильно рассеянных элементов, т.е. часто встречающихся в природе, но присутствует в различных минералах в очень небольших количествах. Его содержание в земной коре составляет около 7·10-4 %, что примерно равно природным запасам таких распространенных металлов, как олово и свинец и существенно превышает количество серебра, кадмия, ртути, сурьмы и др. Тем не менее, получение германия в элементарном виде вызывает большие затруднения. В настоящее время основными источниками промышленного получения германия являются побочные продукты цинкового производства, коксования углей, а также германиевые концентраты, получаемые из медносвинцовоцинковых руд.
Чистый германий обладает металлическим блеском, характеризуется относительно высокой твердостью и хрупкостью, подобно кремнию, он кристаллизуется в структуру алмаза.
Кристаллический германий химически устойчив на воздухе при комнатной температуре. При нагревании его до 650°С он окисляется с образованием двуокиси GeO2.
При комнатной температуре германий не растворяется в воде, соляной и разбавленной серной кислотах. Активные растворители – смесь азотной и плавиковой кислот.
Германий обладает относительно невысокой температурой плавления - 936°С и ничтожно малым давлением насыщенного пара при этой температуре. Ширина запрещенной зоны при изменении температуры изменяется по линейному закону.
Для изготовления полупроводниковых приборов применяют германий с определенными добавками электрически активных примесей. На основе германия выпускается широкая номенклатура приборов самого различного назначения и, в первую очередь, диодов и транзисторов.
Выпрямительные плоскостные диоды рассчитаны на прямые токи от 0.3 до1000 А при падении напряжения не более 0.5 В. Недостатком германиевых диодов являются достаточно невысокие обратные напряжения. Германиевые транзисторы могут быть низко и высокочастотными (НЧ и ВЧ), мощными и маломощными.
Германий используют также для создания лавинно-пролетных и туннельных диодов, варикапов, точечных ВЧ, импульсных и СВЧ-диодов. В импульсных диодах для достижения высокой скорости переключения требуется материал с малым временем жизни неравновесных носителей заряда. Этому требованию удовлетворяет германий, легированный золотом.
Благодаря относительно высокой подвижности носителей заряда, германий применяют для изготовления датчиков Холла и других магниточувствительных приборов.
Оптические свойства германия позволяют использовать его для изготовления фототранзисторов и фотодиодов, оптических линз с большой светосилой, оптических фильтров, а также счетчиков ядерных частиц. Рабочий диапазон германиевых приборов от -60°С до +70°С.
3.8. Кремний
В противоположность германию, кремний является одним из самых распространенных элементов в земной коре, где его содержится 29.5% по массе. По распространенности кремний занимает второе место после кислорода. Многочисленные соединения кремния входят в большинство горных пород и минералов. Песок и глина также представляют собой соединения кремния.
Исходным сырьем при получении кремния является кремнезем, из которого кремний восстанавливают углеродосодержащим материалом в электрических печах.
Кремний кристаллизуется в структуру алмаза с несколько меньшим, чем у германия периодом идентичности кристаллической решетки. Меньшие, чем у германия расстояния между атомами в решетке обуславливают более сильную ковалентную связь и, как следствие этого, более широкую запрещенную зону.
В химическом отношении кремний является относительно инертным веществом. Он не растворим в воде, не реагирует со многими кислотами в любой концентрации. Растворяется в смеси азотной и плавиковой кислот и в кипящих щелочах. Кремний устойчив на воздухе при нагревании до 900°С. Выше этой Т° он начинает активно окисляться с образованием двуокиси кремния SiO2.
Кремний обладает сравнительно высокой температурой плавления и в расплавленном состоянии отличается высокой химической активностью.
Благодаря более широкой запрещенной зоне собственное удельное сопротивление кремния на три с лишним порядка превосходит собственное сопротивление германия.
Кремний является базовым материалом при изготовлении планарных транзисторов и интегральных микросхем.
Несмотря на интенсивное развитие интегральной микроэлектроники, в общем объеме выпуска ПП изделий значительную долю составляют кремниевые дискретные приборы. Из кремния изготавливают выпрямительные, импульсные и СВЧ-диоды, НЧ и ВЧ, мощные и маломощные биполярные транзисторы, полевые транзисторы и приборы с зарядовой связью. Рабочие частоты планарных транзисторов достигают 10 ГГц.
Кремниевые плоскостные выпрямительные диоды могут выдерживать обратные напряжения до 1500 В, существенно превосходя по этим параметрам германиевые. Из кремния изготавливают большинство стабилитронов и тиристоров. Кремниевые стабилитроны в зависимости от степени легирования материала имеют напряжение стабилизации от 3 до 400 В.
Широкое применение в технике нашли кремниевые фоточувствительные приборы, особенно фотодиоды, отличающиеся высоким быстродействием. Для системы энергоснабжения космических аппаратов используются кремниевые солнечные батареи.
Подобно германию, кремний используется для изготовления детекторов ядерных излучений, датчиков Холла и тензодатчиков.
Благодаря более широкой запрещенной зоне, кремниевые приборы могут работать при более высоких температурах, чем германиевые. Верхний предел для них 180-200°С.
3.9. Полупроводниковые соединения типа АIIIВV
Соединения типа АIIIВV являются ближайшими электронными аналогами германия и кремния. Они образуются в результате соединения элементов III группы Периодической системы (бора, алюминия, галлия и индия) с элементами V группы (азотом, фосфором, мышьяком и сурьмой). Висмут и таллий не образуют соединений рассматриваемого ряда.
Соединения АIIIВV принято классифицировать по металлоидному признаку. Соответственно различают нитриды, фосфиды, арсениды и антимониды.
Многообразие свойств полупроводников типа АIIIВV обуславливает их широкое применение в приборах и устройствах различного технического назначения. Особый интерес к этой группе материалов был вызван потребностями оптоэлектроники в быстродействующих источниках и приемниках излучения. Инжекционные лазеры и светодиоды на основе ПП АIIIВV характеризуются высокой эффективностью преобразования электрической энергии в электромагнитное излучение.
Большой набор значений ширины запрещенной зоны у этих полупроводников позволяет создавать на их основе различные виды фотоприемников, перекрывающих широкий диапазон спектра. Среди них наибольшее распространение получили фотодиоды и фотоэлементы.
Арсенид галлия (GaAs) потенциально является одним из лучших фоточувствительных материалов для применения в солнечных батареях.
Антимонид индия (InSb) имеет важное техническое значение для изготовления приемников инфракрасного излучения.
GaAs, InSb применяются для изготовления туннельных диодов. По сравнению с германиевыми диодами, приборы из арсенида галлия характеризуются более высокой рабочей температурой, а диоды из антимонида индия обладают лучшими частотными свойствами при низких температурах.
Прогресс в технологии арсенида галлия, достигнутый за последние годы, открыл широкие перспективы применения этого материала для создания полевых транзисторов и быстродействующих интегральных схем. По сравнению с кремнием GaAs является более технологически сложным материалом. Однако совершенствование технологии различных процессов, разработка новых методов осаждения защитных слоев позволяют реализовать возможности GaAs в повышении степени интеграции и быстродействия ИМС.
3.9.1. Твердые растворы на основе соединений типа АIIIВV
Твердые растворы позволяют существенно расширить по сравнению с элементарными полупроводниками и ПП соединениями набор электрофизических параметров, определяющих возможности применения материалов в конкретных полупроводниковых приборах.
Особый интерес к твердым растворам обусловлен возможностью плавного управления шириной запрещенной зоны полупроводников путем изменения их компонентного состава.
Твердые растворы открывают широкие возможности создания гетеропереходов и приборов на их основе. Под гетеропереходом понимают контакт двух полупроводников с различной шириной запрещенной зоны. Решающим критерием при выборе материала контактной пары является соответствие периодов их кристаллических решеток и температурных коэффициентов их линейного расширения
3.10. Полупроводниковые соединения типа АIIВVI
К соединениям этого типа относят халькогениды цинка, кадмия и ртути. Среди них можно выделить сульфиды, селениды и теллуриды. Но окислы этих металлов сюда не входят.
С ростом атомной массы во всех этих рядах уменьшается ширина запрещенной зоны и температура плавления соединений. Одновременно возрастает подвижность носителей заряда.
Из всех соединений типа АIIВVI по масштабам применения выделяют сульфид цинка ZnS и сульфид кадмия CdS. Первый является основой для многих промышленных люминофоров, второй широко используется для изготовления фоторезисторов.
Помимо сульфида кадмия для изготовления фоторезисторов, чувствительных к видимому излучению, испльзуют пленки и спеченные порошкообразные соли селенида кадмия CdSe.
Узкозонные полупроводники типа АIIВVI представляют интерес для создания приемников ИК-излучения. Пленки из селенида и теллурида ртути применяют для изготовления высокочувствительных датчиков Холла. Монокристаллы этих соединений используют в качестве рабочего тела полупроводниковых лазеров, возбуждаемых электрическим пучком.
3.11. Полупроводниковые соединения типа АIVВVI
Среди полупроводниковых соединений этого типа наиболее изученными являются халькогениды свинца (PbS, PbSe, PbTe). Как узкозонные полупроводники они применяются в качестве детекторов ИК-излучений.
Большой научный и практический интерес представляют твердые растворы на основе теллуридов свинца и олова. Одна из главных причин повышенного интереса к этим материалам связана с использованием их для изготовления фотоприемников с высокой спектральной чувствительностью в диапазоне "атмосферного окна" 8 - 14 мкм, которое соответствует максимуму излучения абсолютно черного тела при 300К.
Перспективно использование твердых растворов для инжекционных лазеров в спектральном диапазоне до 30 мкм.

