Отличительной особенность этих вариантов является замена горелки, используемой в методах MCVD и OVD для нагрева исходных галогенидов и инициирования реакций их окисления или гидролиза, на плазмотрон или магнетрон. Различают два типа вариантов: с использованием ВЧ-плазмы (т.е. изотермической плазмы атмосферного давления) и СВЧ-плазмы (т.е. неизотермической плазмы низкого давления). В первом случае - это методы PMCVD (plasma modified chemical vapor deposition) и POD (plasma outside deposition), а во втором - PCVD (plasma chemical vapor deposition) и его разновидности.
3.4.1. PMCVD и POD методы
В этих методах источником энергии является ВЧ-генератор с индуктивной связью. Мощность ВЧ-генератора обычно составляет ~ 20 кВт, а мощность в разряде до ~ 12 кВт. Частота генератора лежит в диапазоне 13…27 МГц (оптимальная частота ~ 20 МГц). В методе PMCVD внутри индуктора располагается опорная кварцевая трубка диаметром до 40…50 мм, которая совершает возвратно-поступательные движения аналогично движению горелки в классическом методе MCVD. В методе POD кварцевый штабик перемещается перед плазменной горелкой аналогично движению затравочного штабика в методе OVD, и на штабик осаждается слой фторсиликатного стекла, формирующий светоотражающую оболочку. На рис. 3.25 приведены схемы процессов PMCVD и POD.
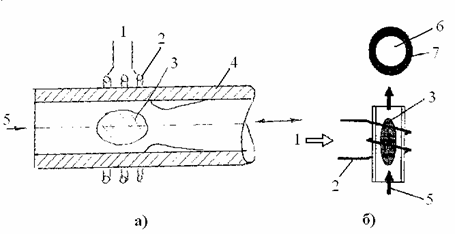
Рис. 3.25. Схема процессов получения заготовок кварцевых ОВ методами PMCVD (а) и POD (б). 1 – подача ВЧ-мощности, 2 – индуктор, 3 – плазма, 4 – опорная кварцевая трубка, 5 – подача реагентов (SiCl4 + O2 + фреоны), 6 – кварцевый штабик, 7 – фторсиликатная оболочка
Пары SiCl4 вместе с кислородом и парами галогенидов легирующих компонентов (GeCl4 или C2F6, C3F6) поступают в опорную трубку (PMCVD) или в плазменную горелку (POD). При средней температуре плазмы 4000…50000С почти все молекулы диссоциируют на отдельные атомы, которые на выходе из плазмы соединяются в частицы оксидов, осаждающиеся на стенках трубки или на поверхности кварцевого штабика. Из-за высокой разности температур на оси плазмы (~ 100000С) и на стенке трубки или штабика имеет место очень сильный термофорез. Высокая температура плазмы в сочетании с сильным термофорезом повышает эффективность образования и осаждения оксидов до 90% для SiO2 и до 85% для GeO2 (вместо 25…40 % в методе MCVD), а также позволяет достигнуть высокого уровня легирования фтором (до 4¸5 масс.% вместо 1,5…2 масс. % в методе MCVD), что обеспечивает числовую апертуру ОВ типа SiO2/SiO2*F до величин 0,22…0,25. В методе PMCVD после осаждения слоев опорная трубка "сжимается" в штабик-заготовку кислородно-водородной горелкой аналогично классическому методу MCVD.
Недостатком методов PMVD и POD является то, что параметры разряда (соответственно плазмы) значительно зависят от состава ПГС. Это делает затруднительным получение заготовок ОВ со сложным профилем ПП и указанные методы используются, в основном, для получения заготовок ОВ со ступенчатым профилем ПП, которые имеют в настоящее время ограниченное применение.
3.4.2. PSVD–метод и его разновидности
В PCVD методе, впервые предложенном и наиболее интенсивно развиваемым фирмой "Philips", для активации процесса образования и осаждения используется неизотермическая плазма низкого давления ~ 10…20 мбар (1 бар = 1,01 атм.), которая по существу является плазмой "тлеющего" СВЧ-разряда. Плазма образуется с помощью СВЧ-резонатора, который соединен с магнетроном мощностью 0,2…6 кВт, излучающего СВЧ на частоте ~ 2,5 ГГц. Смесь О2 и паров SiCl4 вместе c парами галогенидов легирующих компонентов (GeCl4, C2F6 и т.д.), прокачивается через опорную трубку. Схема установки приведена на рис. 3.26. Образование и осаждение слоев чистой и легированной двуокиси кремния осуществляется в опорной кварцевой трубке с наружным диаметром 18…26 мм, вдоль которой перемещается резонатор, а сама трубка вместе с резонатором помещена в печь, нагреваемую до 1150…12000С.

Рис. 3.26. Парофазное осаждение, активированное микроволновой плазмой: 1 – ввод ПГС, 2 – опорная трубка, 3 – печка, 4 – плазма, 6 – магнетрон, 6 – откачка ПГС
В неизотермической плазме температура электронов (~ 100000С) значительно превышает температуру ионов (~ 12000С), которая близка температуре опорной трубки в печи. При этом следует помнить, что температура электронов имеет условный смысл, поскольку обусловлена кинетической энергией электронов в ускоряющем электрическом поле. Под действием электронов и ионов происходит преобразование SiCl4 в моноокись кремния, частицы которой вместе с атомарным кислородом и примесями легирующих компонентов диффундируют к стенке опорной трубки и осаждаются на ее поверхности сразу с образованием стеклообразного слоя чистой или легированной двуокиси кремния (т.е. имеет место гетерогенный процесс). Для протекания реакции окисления галогенидов достаточно энергии плазмы, а нагрев трубки в печи необходим для дегазации слоев от хлора, растворенного в стекле, поскольку в противном случае осажденные слои растрескиваются. Из-за высокой скорости осаждения скорость резонатора можно увеличить до 10…30 м/мин (напомним, что в методе MCVD скорость горелки при осаждении слоев составляет обычно 10…20 см/мин), за счет этого можно увеличить число осаждаемых слоев до 2000 и более с толщиной слоя 0,1…0,5 мкм, что позволяет с большой точностью формировать практически любой профиль ПП. Усовершенствование технологии позволило увеличить скорость осаждения слоев с 0,25 г/мин (1981 г.) до 3,0 г/мин (1985 г.). Характерной особенностью метода PCVD является высокая эффективность осаждения, которая составляет ~ 100% для SiO2, 70…90% дляGeO2 и 50…100% для F в зависимости от используемых фторагентов. На рис. 3. 27 показаны зависимости относительного изменения ПП кварцевого стекла от концентрации легирующих компонентов (GeO2 и F), при этом для сравнения отмечены концентрации фтора, которые удалось ввести в кварцевое стекло различными методами.
Помимо основного метода PCVD были предложены и реализованы другие разновидности СВЧ- методов. В частности, импульсный метод PICVD (plasma impulse chemical vapor deposition), в котором трубка сначала заполняется парами галогенидов с кислородом, затем дается импульс СВЧ-излучения, приводящий к возникновению плазменного столба в трубке, к прохождению реакций и осаждению слоев стекла на стенках трубки. Далее продукты реакции удаляются из трубки потоком газа, трубка вновь заполняется исходной ПГС, подается новый импульс и т.д. Число слоев, осаждаемых в этом методе, составляет 105…106 при толщине слоя ~ 10 А.
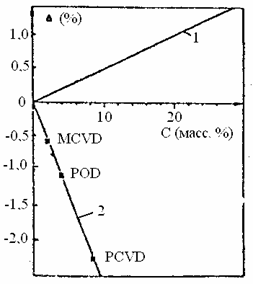
Рис. 3.27. Зависимость относительной разности ПП легированного и чистого кварцевого стекла от концентрации легирующего компонента: 1- германосиликатное стекло, 2 – фторсиликатное стекло
Следующей модификацией СВЧ-плазменных методов является метод SPCVD (surface plasma chemical vapor deposition). Схема установки для получения заготовок этим методом приведена на рис. 3.28. В данном случае длинный плазменный столб "тлеющего" разряда возбуждается в опорной трубке при локальном подводе к ней высокочастотной электромагнитной энергии. Осаждение оксидов происходит на внутренней поверхности опорной трубки в результате реакций в потоке химических реагентов, прокачиваемых через трубку при давлении в несколько мбар. Поддержание плазмы вдали от места приложения высокочастотного поля осуществляется за счет переноса электромагнитной энергии вдоль разряда поверхностными плазменными волнами. По сути плазма, ограниченная опорной кварцевой трубкой, играет роль самоподдерживаемого СВЧ-волновода. По мере удаления от точки приложения СВЧ-поля из-за наличия затухания амплитуда поля поверхностной волны уменьшается, соответственно убывает и концентрация электронов в плазме. Это приводит к тому, что плазменный волновод отрывается в некоторой точке, в которой критическая концентрация свободных электронов в плазме составляет:
![]() = 1,25∙10-8∙f2(1+ε) (см-3) (3.25),
= 1,25∙10-8∙f2(1+ε) (см-3) (3.25),
где f – частота возбуждающего поля и, ε – относительная диэлектрическая постоянная материала трубки. Для f = 2,45 ГГц и ε = 4,8 (кварцевое стекло) величина ![]() равна 4,31´1011 см-3.
равна 4,31´1011 см-3.
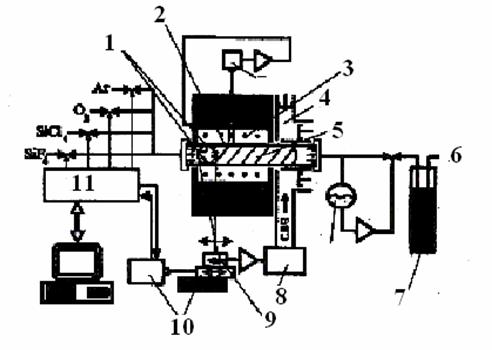
Рис. 3.28. Структура технологической схемы осаждения по методу SPCVD (Surface Plasma Chemical Vapor Deposition): 1 – зона осаждения, 2 – опорнаяф трубка, 3 – печь, 4 – возбудитель разряда, 5 – плазменная колонка, 6 выход к насосу, 7 – азотная ловушка, 8 – магнетрон, 9 – фотодатчик, 10 - подвижка, 11 - интерфейс
Условие распространения плазменных волн следующее:
ne>![]() (3.26),
(3.26),
т.е. концентрация электронов должна быть больше критической. Отсюда следует, что длина плазменной колонны, определенная как расстояние от места возбуждения до обрыва разряда, зависит от того, насколько быстро наступает условие отсечки (3.25). Это в свою очередь определяется величиной коэффициента затухания поверхностной волны и уровнем подводимой к плазме мощности.
При прокачке газовой смеси SiCl4 + O2 через плазменную колонну, изначально нейтральная смесь попадает в разряд со стороны области отсечки плазменного волновода. Именно в окрестности этой области происходят основные плазменно-химические процессы, которые, как говорилось выше, приводят к наработке в газовой фазе молекул SiO, диффундирующих к стенкам трубки, осаждающихся на ней и доокисляющихся до SiO2 , формируя таким образом зону осаждения кварцевого стекла. Изменяя местоположение отсечки плазменного волновода, можно перемещать зону осаждения вдоль труб без перемещения самой трубки, что обеспечивает возможность послойного осаждения стекла периодическим изменением СВЧ-мощности, подводимой к плазме от внешнего источника.
В данном методе при получении фторсиликатной оболочки применяли смесь SiCl4+SiF4+O2 и на поверхности трубки имеет место адсорбция молекул SiO и SiF4, которые формируют стекло. При увеличении температуры в печи от1070°С до 1210°С величина разности ПП кварцевого и фторсиликатного стекол уменьшается от 19∙10-3 до 12∙10-3, а с ростом концентрации SiF4 в ПГС Dn увеличивается, как это видно из рис. 3.29. Большее вхождение фтора в стекло в методе SPCVD по сравнению с методом MCVD объясняется, в частности, более низкой температурой осаждения слоев в первом методе(≈1200°С), чем во втором - (≈1500°С).
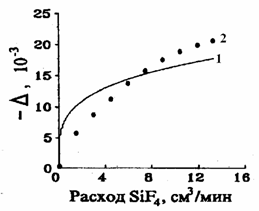
Рис. 3.29. Зависимости относительного изменения ПП фторсиликатного стекла от расхода SiF4: 1 – теоретическая кривая, соответствующая равновесию в системе SiF4 (газ)-SiO2*F(тв.), 2 – экспериментальные данные
Представляет интерес еще одна особенность плазменный методов в отличие от MCVD – возможность легирования кварцевого стекла азотом. На рис. 3.30 приведены профили ПП в заготовках ОВ, сердцевина которых легирована азотом. Видно, что с ростом отношения N2/O2 увеличивается разность ПП стекла, легированного азотом, и чистого кварцевого стекла.

Рис. 3.30. Профили показателя преломления в заготовках световодов, сформированных методом SPCVD на основе кварцевого стекла, легированного азотом при: 1 – N2/O2 = 4,0, 2 - N2/O2 = 2,5, 3 - N2/O2 = 2,0
Так при N2/O2=4 величина Dn увеличивается до 0,03, но при этом растут и потери, обусловленные поглощением N-H-группами и ростом коэффициента рэлеевского рассеяния. Длина волны обертона, обусловленного ОН-группами на l = 1,38 мкм, смещается на λ = 1,505 мкм для NН- групп.Минимальные потери в ОВ, сердцевина которых легирована азотом, составляли 0,575 дБ/км в диапазоне длин волн 1,55…1,7 мкм, что значительно больше, чем в ОВ с германосиликатной или кварцевой сердцевиной.
В заключении приведем таблицу 3.3, суммирующую основные характеристики изложенных выше парофазных методов получения заготовок ОВ на основе высокочистого кварцевого стекла.
Таблица 3.3 Основные парофазные методы получения заготовок кварцевых ОВ и их характеристики
|
Наименование метода |
MCVD |
PMCVD |
PCVD |
OVD |
VAD |
|
Тип химич. реакции |
окисление |
окисление |
окисление |
гидролиз |
гидролиз |
|
Вид подачи энергии |
О2-Н2-горелка |
ВЧ-плазма, О2-Н2-горелка |
СВЧ-плазма |
О2-Н2-горелка |
О2-Н2-горелка |
|
Скорость осаждения г/мин |
0,5 – 2 |
3 – 6 |
0,5 – 2,5 |
до 6 |
до 4,5 |
|
Эффектив. осаждения SiCl4 |
50 – 60 % |
70 – 90 % |
100 % |
50-70 % |
50 – 70 % |
|
Кол-во ОВ из заготовки, км |
5 - 10 |
20 – 50 |
5 - -10 |
> 50 |
50 - 100 |
|
Контроль профиля ПП |
очень легко осуществим |
не легко осуществим |
очень легко осуществим |
легко осуществим |
осуществим |

