1.1.1. Поглощение света, в твердых телах
1.1.2. Виды фотоприемников и их основные характеристики
1.1.4. Фотодиоды с p-n-переходами
1.1.5. Фотодиоды с поверхностными барьерами
1.1.1. Поглощение света в твердых телах


При прохождении света через вещество его интенсивность уменьшается. Часть энергии излучения поглощается и идет на увеличение энергии электронов или теплового движения атомов. На рис. 1.1, а показаны возможные переходы электронов в кристаллах под действием света (Ес—энергия, соответствующая нижнему краю зоны проводимости, Еν — верхнему краю валентной зоны). Переход 1 приводит к появлению электрона в зоне проводимости и дырки в валентной зоне, он возможен при энергии фотонов hν≥ΔE=Ec — Eν, т. е. большей ширины запрещенной зоны ΔЕ. При меньшей энергии фотонов могут происходить переходы электронов с локальных уровней примесей или дефектов решетки кристаллов в зону проводимости (переход 2) или из валентной зоны на эти уровни (переход 3). При этом в разрешенных зонах энергии появляется только по одному носителю заряда. Переходы 1, 2, 3 изменяют электропроводность твердых тел, на этом явлении внутреннего фотоэффекта основана работа большинства фотоприемников.
При внутрицентровых переходах 4 электрон не освобождается и процесс поглощения света не приводит к изменению электропроводности кристалла. То же относится к экситонному поглощению (переход 5) и поглощению свободными носителями заряда (переход 6).
При поглощении электроном фотона должны выполняться законы сохранения энергии и импульса, поэтому более полно процесс поглощения света описывается с помощью диаграммы, учитывающей изменение энергии Е и импульса р. На рис. 1.1, б изображена зависимость от р энергии электрона в зоне проводимости (вверху) и дырки в валентной зоне (внизу). Сплошная линия соответствует полупроводнику, у которого минимумы энергии электрона и энергии дырки (она увеличивается вниз на рисунке) приходятся на одно и то же значение импульса (так называемые прямые зоны). В наиболее простом случае кинетическая энергия электрона связана с импульсом соотношением Е=р2/(2m). Стрелки 1 изображают «прямые» переходы электрона, происходящие без изменения импульса. Импульс фотона, равный hv/с (v- частота, с — скорость света), очень мал, и соответствующим приращением импульса электрона, поглотившего фотон, можно пренебречь. Переход 1/ является «непрямым» и происходит с изменением импульса электрона. При этом в процессе поглощения фотона участвует третья частица — фонон (квант колебательной энергии кристалла).
В случае материалов с прямыми зонами преобладают прямые межзонные переходы, не требующие участия третьей частицы. К веществам, обладающим прямыми зонами, относятся такие используемые в оптоэлектронике материалы, как GaAs (ширина запрещенной зоны ΔЕ=1,4эВ), CdSe (1,8эВ), CdS (2,5 эВ), ZnS (3,7 эВ) и др.
Может осуществляться случай, когда экстремумы энергий электронов и дырок на диаграмме Е(р) приходятся на различные р (штриховая линия на рис. 1.1, 6). Теперь переходы при наименьшей энергии фотонов возможны только непрямые (1//). При более высоких энергиях фотонов сохраняется возможность прямых переходов (1). К материалам с непрямыми зонами относятся, например, Ge (ΔЕ =0,7 эВ), Si (1,1 эВ), AlAs (2,2 эВ), GaP (2,3 эВ) и SiC различных политипов (2,4—3,1 эВ).


Если под действием света осуществляются переходы с участием примесных уровней (переходы 2, 3 на рис. 1.1, а), то третьей частицей, обеспечивающей выполнение закона сохранения импульса, может быть примесный центр.
Количественно поглощение света описывается следующим образом. Пусть на вещество падает поток излучения Фо, а на плоскость на глубине х под поверхностью вещества —поток Ф(х). В слое толщиной dx поглощается энергия dФ(x), которая пропорциональна падающему потоку и толщине dx, т. е. -dФ(х) = αФ(х)dх, где α–коэффициент пропорциональности, и  . Интегрируя, получаем
. Интегрируя, получаем
![]() . (1.1)
. (1.1)
Таким образом, поток излучения экспоненциально уменьшается по мере углубления в образец. Величину α называют коэффициентом поглощения, она выражается в сантиметрах в минус первой степени. При х = х* =1/α имеем Ф(х) = Ф0/е (где е = 2,72), т. е. коэффициент α является величиной, обратной расстоянию х*, на котором поток уменьшается в е раз. Величину х* обычно называют длиной поглощения света. Если при собственном поглощении α=105см-1, то х*= 0,1 мкм. В случае примесного поглощения света α гораздо меньше, так как концентрация примесных электронов или акцепторных уровней сравнительно мала (обычно порядка 1016 —1018 см-3 против 5·1022 см-3 валентных электронов основного вещества).
При концентрации примеси около 1017 см-3 коэффициент примесного поглощения α≈10см-1. В кристаллах с большой долей ионной связи возможно возбуждение колебаний решетки световыми волнами. Поглощение такого типа становится особенно сильным в области резонанса (~1013 Гц).
Поглощение света свободными носителями заряда пропорционально их концентрации.
Различные типы поглощения проявляются при различных энергиях квантов hv. Обобщенная зависимость α от hv выглядит примерно так, как показано на рис. 1.2. Собственное поглощение начинается при частоте v0, соответствующей hv0=ΔE.Примесное поглощение создает полосы 2 и 4 (нумерация полос та же, что и для переходов на рис. 1.1). В широком интервале частот присутствует слабое поглощение света свободными электронами или дырками (6), в инфракрасной области проявляется пик 7, связанный с поглощением излучения ионами решетки (hv≈0,l эВ). У края собственного поглощения располагаются узкие линии экситонного поглощения (5). Экситон представляет собой слабо связанные электрон и дырку, образующие водородоподобную систему, которая имеет серию энергетических уровней. Экситон является нейтральным образованием и его появление не приводит к изменению электрических характеристик образца. Если температура достаточно высока, чтобы под действием тепловой энергии электрон перешел в зону проводимости, то при экситонном поглощении получится тот же результат, что и при собственном поглощении света.
В фотоприемниках обычно используют собственное поглощение. Примесное поглощение используют только в некоторых случаях—для расширения спектральной характеристики в длинноволновую область. Примеры зависимости х* от энергии фотонов hv в области собственного поглощения кристаллов приведены на рис. 1.2, б.
1.1.2. Виды фотоприемников и их основные характеристики
Как уже отмечалось, в основе работы полупроводниковых фотоприемников лежит явление внутреннего фотоэффекта, при котором под действием света в веществе появляются дополнительные (неравновесные) электроны и дырки, создающие фототок или фото-э. д. с.
Степень изменения электрических характеристик фотоприемника при освещении зависит от скорости генерации фотоносителей G, т. е. от числа носителей (электронно-дырочных пар), возникающих за единичное время в единичном объеме вещества. Для фотоприемника с р-п-переходом важна величина G и общее число возникающих пар как в области самого перехода, в которой присутствует сильное электрическое поле, увлекающее носители, так и в тонких слоях, прилегающих к переходу. Возникшие в этих слоях фотоэлектроны и дырки после диффузии к переходу также подхватываются электрическим полем и создают дополнительный ток в цепи. Таково происхождение фототока в фотодиодах с р-п -переходами, которые являются сейчас наиболее используемыми фотоприемниками. То же происходит в запирающих слоях, образующихся на контакте металла и полупроводника. Максимальная напряженность неоднородного поля в переходах обычно имеет порядок 105В/см. На ток некоторых типов фотодиодов, в которых создается поле напряженностью E >5·105 В/см, влияют как скорость генерации носителей светом, так и E (лавинные диоды).
Другой тип фотоприемников представляет собой однородный полупроводник (без запирающих слоев), в котором внешний источник напряжений создает слабое однородное поле (E ≈1·102 В/см). В этом случае фототок зависит от G, E и протяженности образцов вдоль поля.
Чувствительность фотоприемника определяется тем, насколько сильно изменяются его электрические характеристики при облучении светом. Если освещение приводит к росту тока в цепи на Iф, то так называемая токовая чувствительность составляет SI= Iф /Ф, где Ф—поток излучения, падающий на прибор. Если при освещении приемника напряжение на выходе увеличивается на Uф, то вольтовая чувствительность SV= Uф /Ф. Поток Ф может быть выражен как в энергетических единицах (ваттах), так и световых (люменах). В общем случае зависимости Iф (Ф) и Uф (Ф) являются нелинейными, т. е. чувствительность зависит от Ф.
Другой важной характеристикой приемника является квантовый выход внутреннего фотоэффекта η1, определяемый числом неравновесных носителей (пар), которые созданы каждым поглощенным фотоном. Чувствительность фотоприемника зависит от скорости генерации G, которая, в свою очередь, зависит от η1.
Получим выражение для скорости генерации носителей. Пусть на единичную поверхность приемника по направлению х, перпендикулярному этой поверхности, падает поток Ф1(x) (плотность потока излучения). Используя уже приводившееся в п. 1.1.1 выражение для энергии, поглощаемой в слое dx, получим — дФ1(х) = αФ1(х)dх, откуда поглощаемая энергия в расчете на 1 см3 составляет
![]() (1.2)
(1.2)
Число Q1 фотонов, поглощаемых за 1 с в 1 см3 на глубине х, таково: Q1=αФ1/(hv). Число неравновесных носителей, возникающих в 1 см3 за 1с, составляет
![]() (1.3)
(1.3)


В области собственного поглощения η1=1, а Q1~l/v,поэтому при неизменном потоке Ф1скорость генерации G также уменьшается обратно пропорционально частоте. Фототок и чувствительность SI пропорциональны G и имеют ту же зависимость от v (рис. 1.3, а).
Как отмечалось, у одних типов приемников (обычные фотодиоды) фототок полностью определяется величиной G(x) и объемом материала, в котором происходит поглощение света, у других (лавинный фотодиод, фоторезистор, фототранзистор)—величиной G(x)·Z(E) где Z(E ) — коэффициент усиления, зависящий от напряженности поля E. Значения Z, которые отражаются и на чувствительности приборов, приведены в табл. 1.1. Причины появления этого множителя различны для разных приемников и будут рассмотрены позже.
Таблица 1.1. Типичные значения коэффициента усиления и времени фотоответа
|
Фотоприемник |
Коэффициент усиления |
Постоянная времени |
|
Фоторезистор Фотодиод с р-п-переходом Диод с p-i-n переходом Диод с поверхностным барьером Лавинный фотодиод Фототранзистор |
1-105 1 1 1 102-104 102 |
10-2-10-7 10-6-10-8 10-8-10-10 10-10 10-9 10-6 |
Фотоприемники не мгновенно откликаются на включение и выключение света (рис.1.3,б). Подобная инерционность приемников имеет различное происхождение, формально же она может быть охарактеризована постоянными времени нарастания и спада фототока. Для спада тока постоянная времени τ2 соответствует уменьшению тока в е раз. При этом предполагается, что фототок уменьшается по закону Iф = Iмехр( — t/ τ 2). Если рост тока идет по закону Iф = Iм(1-e -t/ τ 1), то τ1 —постоянная времени нарастания фототока. К моменту t= τ1 имеем Iф≈63%Iм . Постоянные времени τ 1 и τ 2 могут несколько различаться, но имеют, как правило, один порядок. Типичные значения т приведены в табл. 1.1.
Токи, идущие через фотоприемник в темноте и при освещении, испытывают случайные отклонения ΔI от среднего значения тока ![]() . Так как эти отклонения имеют разные знаки и их среднее значение
. Так как эти отклонения имеют разные знаки и их среднее значение ![]() , мерой случайных отклонений (флуктуации) является среднее значение квадрата отклонения
, мерой случайных отклонений (флуктуации) является среднее значение квадрата отклонения ![]() . Фототок, соответствующий световому сигналу, наблюдается на фоне этих колебаний (шумов), которые определяют и наименьший световой сигнал, который может быть зарегистрирован.
. Фототок, соответствующий световому сигналу, наблюдается на фоне этих колебаний (шумов), которые определяют и наименьший световой сигнал, который может быть зарегистрирован.
Шумы могут иметь различное происхождение. Так называемый тепловой шум связан с тем, что вследствие хаотичности теплового движения свободных электронов их концентрация в различных участках полупроводника изменяется со временем. Связанные с этим колебания возникающей э. д. с. и тока пропорциональны температуре Т:
![]() (1.4)
(1.4)
где k—постоянная Больцмана, R—сопротивление образца, а Δf—полоса наблюдаемых частот колебаний (колебания произвольной формы могут быть представлены как результат сложения синусоидальных колебаний с различными частотами f)
Дробовый шум вызван колебанием числа электронов, проходящих через прибор при неизменном внешнем напряжении. Эти колебания также связаны с флуктуациями концентрации носителей в тех областях прибора, которые определяют значение силы тока. В этом случае
![]() , (1.5)
, (1.5)


где q—-заряд электрона. Шум такого типа может определяться случайным характером процессов генерации, рекомбинации и диффузии электронов и дырок. Существуют и другие виды шумов, в разной мере проявляющихся в разных устройствах. Пороговая чувствительность фотоприемника характеризуется уровнем светового потока Фп, при котором сигнал равен шуму, т.е.![]() . Так как
. Так как ![]() и Фп могут зависеть от площади s приемника и полосы частот Δf, при оценке способности фотоприемника регистрировать слабые световые потоки используется приведенный пороговый поток
и Фп могут зависеть от площади s приемника и полосы частот Δf, при оценке способности фотоприемника регистрировать слабые световые потоки используется приведенный пороговый поток ![]() , а также так называемая обнаружительная способность
, а также так называемая обнаружительная способность ![]() . Значения D* относят обычно к длине волны λм, соответствующей максимуму спектральной чувствительности приемника, к определенной частоте f модуляции (прерывания) светового потока и полосе Δf, включающей f. Таким образом, D * (λм, f, Δf) имеет размерность [см • Гц1/2 Вт-1 ]. Обычно Δf = 1 Гц.
. Значения D* относят обычно к длине волны λм, соответствующей максимуму спектральной чувствительности приемника, к определенной частоте f модуляции (прерывания) светового потока и полосе Δf, включающей f. Таким образом, D * (λм, f, Δf) имеет размерность [см • Гц1/2 Вт-1 ]. Обычно Δf = 1 Гц.
1.1.3. Фоторезисторы
При освещении однородного полупроводника его электропроводность увеличивается (У.Смит, 1873). Это явление называют фотопроводимостью, а соответствующий прибор — фоторезистором. Схема наблюдения фотопроводимости показана на рис. 1.4, а. Если под действием света возникают только электроны в зоне проводимости, то добавочный ток (фототок) Iф = qnфυds, где q — заряд электрона; пф — концентрация неравновесных (избыточных) электронов; υd =μ E — дрейфовая скорость; μ — подвижность электронов; E — напряженность поля; s—сечение образца. Если свет создает электронно-дырочные пары, то возникает и дырочная составляющая фототока. В большинстве случаев, однако, добавочная концентрация дырок (либо электронов) мала по сравнению с их темновой концентрацией или подвижность носителей заряда определенного знака мала в данном веществе, поэтому достаточно рассматривать фототок, связанный с носителями только одного типа.
Концентрация фотоэлектронов определяется скоростью генерации и временем τ их жизни в полосе проводимости: nф = Gτ. С помощью выражения (1.3) получим, что у освещенной поверхности (х = 0) скорость генерации
![]() ,
,
где Ф1(0) — плотность падающего светового потока. Полагая, для простоты, что генерация идет равномерно по объему в слое полупроводника толщиной х* (в этом слое поглощается 2/3 фотонов), получим
![]() (1.6)
(1.6)
Так как α=1/х*, общий световой поток Ф = Ф1аb, а произведение τυd имеет смысл расстояния у, которое проходит электрон за время τ, фототок
![]() , (1.7)
, (1.7)
где y = τυd= τ μ E. Фототок растет с увеличением Ф и напряженности поля E (или напряжения U=b E).
Квантовый выход η2фоторезистора равен числу электронов, прошедших через образец за 1 с в расчете на каждый фотон, упавший за то же время на поверхность образца:
![]() . (1.8)
. (1.8)
Здесь Z—коэффициент усиления, зависящий от напряженности поля. В данном случае Z показывает, сколько раз за время жизни τ электрон может пройти через образец длиной b. С увеличением напряженности поля у растет и Z может достигать значений 1·105. Выражение для выхода (1.8) соответствует случаю, когда отражения света от поверхности полупроводника нет. Если коэффициент отражения r>0, то η2=η1Z(1-r). Для германия в области собственного поглощения r=0,4÷0,5.
Из выражения (1.7) следует, что фототок пропорционален Ф. Экспериментальные зависимости Iф(Ф) показывают ослабление зависимости Iф(Ф) при больших световых потоках (рис. 1.4,6). Это связано с тем, что при больших Ф и соответствующих ηф время жизни τ электронов может уменьшаться, например, из-за увеличения при освещении концентрации носителей противоположного знака (в данном случае—дырок).
В области собственного поглощения с ростом частоты может наблюдаться уменьшение Iф, связанное с падением τ в тонких слоях полупроводника у поверхности вследствие более быстрой рекомбинации носителей через локальные энергетические состояния.
Инерционность фоторезисторов определяется часто не столько временем τ, сколько участием ловушек (рис. 1.4, в). После попадания электронов в полосу проводимости они могут захватываться пустыми уровнями примесей или дефектов решетки, причем время нахождения электронов на этих уровнях растет с увеличением их глубины и с понижением температуры. Только после теплового освобождения электронов они могут рекомбинировать с дырками (переход R). Процессы захвата носителей ловушками («прилипание» электронов и дырок) весьма затягивает рост фототока после включения света и спад после его выключения. В результате фоторезисторы обладают большей, чем другие фотоприемники, инерционностью (табл. 1.1). Как это обстоятельство, так и температурная зависимость параметров резисторов ограничивают их использование.
Фоторезисторы могут иметь в качестве чувствительного элемента монокристалл полупроводника, пленку полупроводника на диэлектрике или таблетку прессованного порошкообразного материала. Последний способ применяют, например, при изготовлении промышленных фоторезисторов из сульфида или селенида кадмия. Фоторезисторы на основе селенида кадмия (типа ФСД) имеют темновое сопротивление ~106 Ом, максимум спектральной характеристики в области 0,7 мкм, работают при напряжении 20 В и имеют постоянные времени роста и спада фототока τ1 = 40 мс и τ2 = 20 мс. Их интегральная чувствительность при использовании общего излучения теплового источника света с цветовой температурой 2840 К составляет SI = 600 мА/лм (при освещенности 200 лк).
Фоторезисторы на основе сульфида свинца являются менее инерционными (τ = 0,1 мс) и обладают высокой обнаружительной способностью D* (2,4 мкм, 780 Гц, 1 Гц) = 1,5 · 1011 см· Гц1/2 ·Вт-1 при 295 К. Понижение температуры приводит к увеличению D*.
1.1.4. Фотодиоды с p-n-переходами


В фотодиодах светочувствительным элементом является переходная область, расположенная между материалами с электронной и дырочной проводимостью. На рис. 1.5, а изображена энергетическая схема p-n-перехода в равновесии. Уровень Ферми ЕF во всех частях системы имеет одно и то же положение. Область с дырочной проводимостью содержит акцепторные примеси А, на которые электроны теплом переводятся из валентной зоны, область с электронной проводимостью—донорные примеси D, которые отдали свои электроны в зону проводимости. В области шириной d0 присутствует контактное поле, образовавшееся в результате перетока некоторого числа электронов из электронного полупроводника в дырочный. Это поле затрудняет попадание электронов и дырок в слой do, который оказывается обедненным носителями и определяет ток через диод.
При освещении р-п-перехода светом с энергией фотонов больше ширины запрещенной зоны (ΔE=EC — EV) по обе стороны от перехода и в самом переходе возникают пары электрон—дырка. Пары, возникающие в области d0, сразу разделяются электрическим полем, причем электроны движутся в область с электронной проводимостью, а дырки — в область с дырочной проводимостью (рис. 1.5,6). Кроме того, в переход попадают электроны, созданные светом в слое l1 левее перехода, так как после освобождения электроны за время жизни τ успевают проходить среднее расстояние l1 (диффузионная длина). То же относится к дыркам в слое l2 правее перехода. При τ= 1·10-6 с и коэффициенте диффузии носителей D = 25 см2·c-1 длина l=5·10-3 см (![]() ).
).
Если на переход не подано внешнее напряжение и цепь разомкнута (как это предполагается на рис 1.5,б), то освещение приводит к накоплению фотоэлектронов в п-области и дырок в р-области. В результате образуется разность потенциалов Uф, т. е. появляется фото-э.д.с. Если внешняя цепь замкнута, то возникает фототок. В таких условиях диод работает как фотоэлемент.
Для преобразования энергии солнечных лучей в электрическую используют р-п-переходы в кремнии (ΔЕ=1,1эВ), когда почти все фотоны солнечного излучения способны создавать электронно-дырочные пары. Фото-э. д. с. таких фотоэлементов составляет несколько десятых долей вольта, поэтому их часто соединяют последовательно для получения напряжения в несколько вольт (солнечные батареи для космических аппаратов и других целей).
Напряжение Uф смещает переход в прямом направлении, снижает высоту барьера для электронов и дырок, что облегчает переток быстрых электронов в р-область. По мере увеличения Ф рост Uф поэтому замедляется (рис. 1.5, б). Вольт-амперную характеристику р-п -перехода при освещении можно записать следующим образом:
 , (1.9)
, (1.9)
где Iн – ток насыщения в темноте; Iф—фототок, проходящий через переход; U—внешнее напряжение на переходе. Если во внешней цепи I=0, a U=Uф, то из (1.9) получим
 . (1.10)
. (1.10)
Так как IФ~Ф, то из (1.10) следует нелинейная зависимость Uф («напряжения холостого хода») от Ф. Если фотоэлемент включен во внешнюю цепь с малым сопротивлением, то фотоэлектроны не накапливаются в п-области и Uф = 0. Поскольку внешнее напряжение тоже отсутствует, I= -IФ, т.е. в этом случае ток (называемый часто током короткого замыкания) IФ~Ф (рис. 1.5, в).
Если p-n-переход включен в запирающем направлении (на p-область подан минус источника напряжения), то практически все напряжение будет падать на обедненной области шириной d и схема энергетических зон приобретет вид, показанный на рис. 1.6, а.
Теперь разделение электронов и дырок, возникших при освещении, производится более сильным полем, а ширина области высокого сопротивления увеличивается (d~![]() ). Это увеличивает ту часть кристалла, из которой электроны и дырки быстро уносятся полем. Если дрейфовая скорость электронов υd=1·106 см/с, а d=10-4см, то время пролета электронами области поля τi=1·10-10 с. С такой же быстротой эта составляющая фототока будет следовать за изменением интенсивности света. Однако через переход проходят и электроны (дырки), рожденные светом в слоях l1 и 12и достигшие перехода путем диффузии. Соответствующие времена гораздо больше (тд≈1·10-7 с) и именно они могут определять инерционность фотодиода. Для ослабления этой составляющей фототока p-п-переход следует формировать у самой освещаемой поверхности (уменьшая, например, толщину х1 слоя p-типа).
). Это увеличивает ту часть кристалла, из которой электроны и дырки быстро уносятся полем. Если дрейфовая скорость электронов υd=1·106 см/с, а d=10-4см, то время пролета электронами области поля τi=1·10-10 с. С такой же быстротой эта составляющая фототока будет следовать за изменением интенсивности света. Однако через переход проходят и электроны (дырки), рожденные светом в слоях l1 и 12и достигшие перехода путем диффузии. Соответствующие времена гораздо больше (тд≈1·10-7 с) и именно они могут определять инерционность фотодиода. Для ослабления этой составляющей фототока p-п-переход следует формировать у самой освещаемой поверхности (уменьшая, например, толщину х1 слоя p-типа).
Так как большая часть света поглощается на глубине х* = 1/α (где α—коэффициент поглощения), то при х1≈0 и d=x* роль света, поглощаемого в слое l2, и приходящих оттуда дырок также ослаблена (рис. 1.6, а). Чтобы полностью исключить поглощение света правее перехода, можно увеличить d до 2х*. Этого достигают в специальных p-i-n-переходах, в которых между слоями с высокой концентрацией акцепторов и доноров располагают слой с собственной проводимостью (i).
Графики вольт-амперных зависимостей p-n-перехода при освещении приведены на рис.1.6,б. При включении перехода в запирающем направлении (U< 0) и при qU>>kT из (1.9) следует, что I= – (Iн + Iф). По мере повышения Ф фототок Iф увеличивается и может значительно превысить темновой ток Iн.


Если весь световой поток Ф, падающий на фотодиод, поглощается в слое толщиной x1+d+l2 (т. е. эта толщина больше 2х*), то все возникшие электроны и дырки примут участие в создании фототока и
![]() (1.11)
(1.11)
где η1 — квантовый выход процесса генерации электронно-дырочных пар. В этом случае квантовый выход фотодиода η3 =η1. Если часть электронов и дырок рождается за пределами слоя l1 + d+l2, то η3= η1Кс, где Кс— коэффициент собирания фотоэлектронов и дырок (Кс < 1). Отражение света от поверхности полупроводника также уменьшает квантовый выход фотодиода. В отличие от фоторезисторов рассматриваемые фотодиоды не обладают внутренним усилением (Z=l) и их общая чувствительность составляет примерно 20 мА/лм.

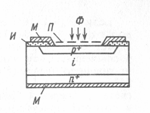
В кремниевом p-i-n-диоде, который является одним из наиболее распространенных фотодетекторов (рис. 1.7), толщина i-области составляет примерно 50 мкм, а слоя р+ — всего 3 мкм. При освещении такого диода светом с длиной волны λ= 0,9 мкм (от GaAs-излучателя) x*=30 мкм и около 80% света поглощается в i-слое. Следовательно, практически все фотоэлектроны и дырки возникают в i-слое, и быстродействие диода определяется временем τi их пролета через i-слой. Дрейфовая скорость электронов в кремнии сначала растет c увеличением напряженности поля, а затем испытывает насыщение при Ud ≈ 5·106 см/с. В этих условиях время пролета
![]()
а время τд, определяемое диффузией электронов из р-области или дырок из п-области (τд > τi), не играет существенной роли.
В общем случае следует учитывать еще одну составляющую τRC постоянной времени, связанную с сопротивлением R и емкостью С цепи. При малом сопротивлении нейтральных областей диода, а также внешней цепи, при широком переходе (зарядовая емкость р-п-перехода C~d-1, a d~![]() ) имеем τRC < τi. Обнаружительная способность кремниевых фотодиодов достигает значения 1·1013 см-Гц1/2 ·Вт-1 (λ = 1мкм, Т=300 К).
) имеем τRC < τi. Обнаружительная способность кремниевых фотодиодов достигает значения 1·1013 см-Гц1/2 ·Вт-1 (λ = 1мкм, Т=300 К).
1.1.5. Фотодиоды с поверхностными барьерами
Фотоприемники с поверхностным барьером Шоттки также обладают высоким быстродействием и эффективностью. Подобные барьеры, образующиеся на контакте металла с полупроводником (рис. 1.8), могут быть получены и на материалах, в которых невозможно создать р-п-переходы.
Если электронный полупроводник контактирует с металлом, у которого работа выхода электронов меньше работы выхода для полупроводника, то определенное число электронов переходит из полупроводника в металл. Ионизованная донорная примесь в полупроводнике образует слой положительного пространственного заряда, обладающий высоким сопротивлением. При включении диода в запирающем направлении (минус на металле) ширина барьера увеличивается в соответствии с формулой


 (1.12)
(1.12)
где ε-диэлектрическая проницаемость; ε0 — электрическая постоянная; UK — контактная разность потенциалов; U—внешнее напряжение;
Nd — концентрация доноров.
Если Nd =1·1017 см-3, то при напряжении в несколько вольт d ≈ 1·10-5 см. Тонкий слой металла толщиной 1·10-6 см| может быть нанесен на полупроводник методом вакуумного распыления. Свет направляют на кристалл сквозь эту почти прозрачную пленку (в случае диода Аu — Si слой Аu пропускает 95% излучения с λ = 0,63 мкм). Если d >x*, то основная часть света с энергией фотонов hv > ΔЕ поглощается в области, в которой присутствует сильное электрическое поле (переход 2 на рис. 1.8). Возникшие пары быстро разделяются полем и время пролета τi может быть сделано очень малым (τi=10-10 –10-11 с), особенно в том случае, когда х* и толщина d меньше 1 мкм.
По мере увеличения частоты уменьшается х* и область поглощения света сдвигается к металлическому слою. Тем не менее вследствие близости барьера к поверхности это поглощение остается в пределах поля барьера и диффузионная составляющая тока отсутствует. Чувствительность диодов Шоттки, как и p-i-n-переходов, является высокой и достигает SI = 0,5 А/Вт. Особенностью барьеров Шоттки является возможность регистрации фотонов с hv<ΔE. При энергии фотонов, большей высоты барьера со стороны металла, электроны могут вводиться в полупроводник из металла (переход 1 на рис. 1.8). Соответственно расширяется область спектральной чувствительности фотодиода.
Чтобы предупредить сильное отражение света от поверхности диода, на нее наносят просветляющее покрытие, например пленку сульфида цинка с коэффициентом преломления 2,30 для λ=0,63 мкм. Толщину пленки устанавливают такой, чтобы при интерференции лучей, отраженных от границ пленки, получался минимум, т. е. чтобы отражение отсутствовало для лучей данной λ.
1.1.6. Лавинные фотодиоды
Если к фотодиоду приложить достаточно высокое обратное напряжение, то напряженность поля E в барьере оказывается настолько высокой (5·105 — 1·106 В/см), что развиваются процессы ударной ионизации атомов решетки ускоренными электронами. Это приводит к росту обратного тока при данном световом потоке Ф (рис. 1.9). Как темновые, так и фотоэлектроны приобретают в высоком поле энергию, большую, чем они теряют при столкновениях с атомами решетки. Если полученная электроном энергия превышает энергию ионизации Еi (обычно ΔЕ<Еi<1,5ΔЕ), то электрон может создать новую электронно-дырочную пару. При достаточно протяженной области поля возникшие электрон и дырка тоже могут ускориться до энергии Еi и совершить новые ионизации, т. е. будет наблюдаться лавинное нарастание числа носителей заряда.


Увеличение тока вследствие ионизации при больших E характеризуется коэффициентом умножения носителей М=I/I0, где I—ток при больших напряжениях U, а I0—при малых, когда умножения носителей еще нет. Иначе, М = п/п0, где n0 — число электронов, вошедших в область поля, а п — число вышедших. Величина М отражает общее число ионизации, совершенных как первичными, так и вторичными электронами и дырками, она определяется выходом процесса ионизации ![]() , т. е.
, т. е. ![]() , где N—число ионизации, приходящихся на один электрон, прошедший область поля.
, где N—число ионизации, приходящихся на один электрон, прошедший область поля.


Квантовый выход ионизации зависит от коэффициентов ударной ионизации (числа пар, созданных электроном на 1 см пути) для электронов (αi) и дырок (βi), a также от ширины d области поля. При αi = βi и однородном поле шириной d имеем N= αi βi в случае неоднородного поля  . Так как αi ~exp(-c1/ E 2), а для барьера Шоттки E ~
. Так как αi ~exp(-c1/ E 2), а для барьера Шоттки E ~![]() (U— напряжение на барьере), то N может быть представлено в виде N=a1 exp(—b1U), где а1, b1 и с1— постоянные. Значение N изменяется от 0 при малых U до 1 при напряжении пробоя UB, когда ток через диод резко возрастает (М→∞). На практике часто используется степенное представление зависимости N(U), а именно N = (U/UВ)m, где т = 2…4 для разных материалов.
(U— напряжение на барьере), то N может быть представлено в виде N=a1 exp(—b1U), где а1, b1 и с1— постоянные. Значение N изменяется от 0 при малых U до 1 при напряжении пробоя UB, когда ток через диод резко возрастает (М→∞). На практике часто используется степенное представление зависимости N(U), а именно N = (U/UВ)m, где т = 2…4 для разных материалов.
Лавинное умножение фотоносителей получено как в поверхностных барьерах (рис. 1.9), так и в р-п-переходах. При больших U сильные токи ведут разогрев полупроводника, что увеличивает темновой ток и уменьшает фототок (электрический пробой переходит в тепловой). Коэффициент умножения определяет и коэффициент внутреннего усиления фотодиода (Z = М). Так как М может достигать значений 1•103, лавинный диод пригоден для регистрации очень слабых световых сигналов. В то же время из-за сильной зависимости M(U) использование лавинных диодов затрудняется необходимостью применения высокостабильного напряжения.
Инерционность лавинных фотодиодов составляет около 1·10-9 с.
1.1.7. Фототранзистор и фототиристор
Фототранзистор (рис. 1.10) представляет собой структур из чередующихся слоев р-п-р и п-р-п (рис. 1.10, а). Внешне напряжение (минус на эмиттере) включает эмиттерный р-п-переход в прямом, а коллекторный переход — в обратном направлениях. В темноте практически все внешнее напряжение падает на коллекторном переходе. Освещение средней части (базы) ведется через тонкий слой эмиттера. Возникающие в базе и в обоих переходах фотоэлектроны попадают в области эмиттера и коллектора, а дырки собираются в средней области. В результате к левому р-п-переходу оказывается приложенным дополнительное напряжение в прямом направлении и возникает инжекция темновых электронов через сниженный барьер в базу и далее—в коллекторный переход Таким способом первоначальный ток фотоносителей может быть усилен примерно в 1·102 раз. Соответственно чувствительность фототранзистора значительно выше чувствительности обычного фотодиода. С другой стороны, участие процессов диффузии носителей заряда увеличивает инерционность прибора, и постоянная времени τ= – 10-5 — 10-6 с.
Сужение базы, необходимое для уменьшения т, приводит к уменьшению чувствительности фототранзистора вследствие уменьшения числа поглощенных фотонов. Отсюда следует, что эффективный фотодиод и малоинерционный транзистор, используемый для усиления тока фотодиода, целесообразно изготовлять раздельно.
Интегральная чувствительность германиевого фототранзистора (ФТ-1) равна 0,2—0,5 А/лм, рабочее напряжение 3 В, темновой ток 300 мкА.
Как известно, тиристор имеет чередующиеся слои р, п, р, п-типов проводимости и соответственно три р-п-перехода, из которых средний называют коллекторным, а два крайних — эмиттерными. Структура включается так, чтобы коллекторный переход был включен в обратном направлении, а оба эмиттерных — в прямом (плюс источника — на внешней р-области структуры, а минус—на п-области).
Если напряжение на всем тиристоре повысить до Uп, при котором эмиттерные переходы заметно понизятся (или при U<Uп, но с помощью управляющего электрода от одной из баз эмиттерный переход включается в прямом направлении), то через тиристор начинает течь значительный ток, который приводит к накоплению в р-базе положительного заряда, а в п-базе — отрицательного. Это снижает высоту боковых р-п-переходов и вызывает новый резкий рост тока. При этом общее падение напряжения на тиристоре снижается, так как токи сами теперь поддерживают нужную степень накопления зарядов. Таким образом, тиристор может находиться в двух состояниях, соответствующих большим или малым токам, т. е. тиристор может работать как ключ в электрической цепи.
У фототиристора накопление положительного и отрицательного зарядов, необходимых для перевода его во включенное состояние, производится при облучении светом из области собственного поглощения материала. Поле среднего перехода направляет фотодырки в р-базу, а электроны в п-базу, что снижает высоту обоих эмиттерных барьеров и создает сильные темновые токи через тиристор. Таким образом, свет играет роль управляющего электрического сигнала у тиристора с третьим выводом (от базы) и позволяет бесконтактным способом управлять токами в различных электрических цепях.
1.1.8. Многоэлементные фотоприемники
В ряде случаев надо не только отметить наличие пучка Света или его интенсивность, но и зафиксировать фотоэлектрическим способом оптическое изображение, имеющее определенное распределение интенсивности света по плоскости. Этого можно достигнуть, изготовив экран, состоящий из множества миниатюрных фотоприемников, которые преобразуют световые потоки в соответствующие электрические сигналы. Записанная таким образом оптическая информация некоторое время сохраняется, а затем «считывается» тем или иным способом. Электрические сигналы от различных ячеек экрана могут быть последовательно переданы в другое место и использованы для воссоздания изображения объекта (фототелеграфия, телевидение).


В ряде систем записи оптических сигналов применяют полупроводниковые устройства, а при считывании информация используют электронный пучок, быстро обегающий миниатюрные фотодетекторы. Использование электронных пучков означает, однако, применение вакуумных трубок с высоковольтными устройствами для управления пучками, которые плохо согласуются с низковольтными полупроводниковыми схемами. Далее в качестве примера рассматривается многоэлементный фотоприемник, у которого запись, хранение и считывания информации осуществляются одними и теми же твердотельными элементами. В качестве такого элемента может быть использована структура металл — диэлектрик — полупроводник (МДП), схема которой приведена на рис. 1.11, а.
Если к структуре прикладывают напряжение U (минус на металле), то часть примесных электронов выводится из полупроводника п-типа, что приводит к появлению слоя положительного объемного заряда толщиной d. Толщина этого слоя увеличивается с ростом U. Возникающие при освещении МДП-структуры электроны отводятся в объем полупроводника, а дырки скапливаются у границы с диэлектриком. Число этих дырок (т. е. общий положительный заряд) зависит от интенсивности света и времени его действия. Накопленный заряд (т. е. информация, заданная светом) может длительное время сохраняться, если тепловая генерация пар незначительна.
На рис. 1.11,б изображена цепочка МДП-структур, являющаяся частью строчки многоэлементного фоточувствительного экрана. В случае I на структуру не подано внешнее напряжение и наличие обедненного электронами слоя толщиной d0 связано с контактной разностью потенциалов UК. Случай II соответствует присутствию внешнего напряжения и освещения структуры сквозь полупрозрачный металлический электрод (затвор). Накопленный за время освещения заряд дырок может быть сдвинут вдоль цепочки структур, если на соседний элемент подано более высокое напряжение (случай III). В этом случае глубина потенциальной ямы для дырок больше, и они вследствие диффузии перейдут от второго элемента к третьему. В промежутке между затворами 2 и 3 присутствует ускоряющее дырки поле, которое проникает и в область скопления дырок, поэтому переток дырок к элементу 3 может быть достаточно быстрым.
Таким способом электрический сигнал от элемента 2, пропорциональный интенсивности Ф и времени действия света, падавшего на этот элемент, может быть проведен по цепочке элементов и выведен во внешнюю цепь. Аналогичным образом могут быть получены видеосигналы от других элементов строки и элементов других строк.
Таким образом, микроскопические фоточувствительные элементы расположены в строке настолько близко (l≈3 мкм), что они могут взаимодействовать, передавая друг другу заряды. Отсюда название подобных устройств — приборы с зарядовой (или объемной) связью. Эта связь между МДП-структурами осуществляется через общую для всех структур толщу полупроводников.
Регистрирующие изображения устройства рассмотренного типа (из МДП-элементов) потребляют малую энергию во время считывания, требуют небольших напряжений (10—20 В) при числе элементов ~1·105см-2 могут иметь хорошую разрешающую способность (40 линий на I мм). Высокая чувствительность экрана определяется тем, что он работает в условиях накопления светового действия. Так как в чувствительных элементах используют не р-п-переходы, а поверхностные барьеры, облегчается подбор области спектральной чувствительности прибора путем выбора материала с соответствующей шириной запрещенной зоны (ΔЕ≤hν).
Кремниевые приборы с зарядовой связью обладают рядом преимуществ по сравнению с вакуумными передающими телевизионными приборами, имеют высокий срок службы (1•104 ч) и используются, в частности, для регистрации слабых изображений, создаваемых оптическими телескопами.

