1.1. Общие сведения о полупроводниках
1.1.1. Полупроводники с собственной проводимостью
1.3.1. Электронно-дырочный переход в состоянии равновесия
1.3.2. Прямое включение p-n перехода
1.3.3. Обратное включение p-n перехода
1.3.4. Теоретическая характеристика p-n перехода
1.4. Разновидности p-n переходов
1.4.2. Контакт между полупроводниками одного типа проводимости
1.1. Общие сведения о полупроводниках
1.1.1. Полупроводники с собственной электропроводностью
К полупроводникам относятся вещества, которые по своим электрическим свойствам занимают промежуточное положение между проводниками и диэлектриками.
Отличительным признаком полупроводников является сильная зависимость их электропроводности от температуры, концентрации примесей, воздействия светового и ионизирующего излучений.
В создании электрического тока могут принимать участие только подвижные носители электрических зарядов. Поэтому электропроводность вещества тем больше, чем больше в единице объема этого вещества находится подвижных носителей электрических зарядов. В металлах практически все валентные электроны (являющиеся носителями элементарного отрицательного заряда) свободны, что и обусловливает их высокую электропроводность. Например, удельное сопротивление меди r =0,017× 10-6 Ом× м. В диэлектриках и полупроводниках свободных носителей значительно меньше, поэтому их удельное сопротивление велико. Например, для диэлектрика полиэтилена r = 1015 Ом× м, а для полупроводника кремния r = 2× 103 Ом× м.
Характерной особенностью полупроводников является ярко выраженная температурная зависимость удельного электрического сопротивления. С повышением температуры оно, как правило, уменьшается на 5...6% на градус, в то время как у металлов удельное электрическое сопротивление с повышением температуры растет на десятые доли процента на градус. Удельное сопротивление полупроводника также резко уменьшается при введении в него незначительного количества примеси.
Большинство применяемых в настоящее время полупроводников относится к кристаллическим телам, атомы которых образуют пространственную решетку. Взаимное притяжение атомов кристаллической решетки осуществляется за счет ковалентной связи, т. е. общей пары валентных электронов, вращающихся по одной орбите вокруг этих атомов. Согласно принципу Паули, общую орбиту могут иметь только два электрона с различными спинами, поэтому число ковалентных связей атома определяется его валентностью.
Каждой орбите соответствует своя энергия электрона. Электрон в атоме обладает только некоторыми, вполне определенными значениями энергии, составляющими совокупность дискретных энергетических уровней атома.
В процессе образования кристаллической решетки между атомами возникает сильное взаимодействие, приводящее к расщеплению энергетических уровней, занимаемых электронами атомов (рисунок 1.1). Совокупность этих уровней называют энергетической зоной. Число подуровней в каждой зоне определяется числом взаимодействующих атомов.
Разрешенные энергетические зоны 1, 3 отделены друг от друга запрещенной зоной 2. Запрещенная зона объединяет уровни энергий, которые не могут принимать электроны атомов данного вещества. Поскольку ширина разрешенных зон в твердом теле не превосходит несколько электрон-вольт (эВ), а число атомов в 1 см3 достигает 1022, разность между уровнями составляет 10-22 эВ. Таким образом, в пределах разрешенной зоны получается практически непрерывный спектр энергетических уровней.

Рисунок 1.1. Энергетическая диаграмма кристалла.
Верхняя разрешенная зона, в которой при абсолютном нуле температуры все энергетические уровни заняты, называется заполненной или валентной зоной (на рисунке 1.1. это зона 3). Разрешенная зона, в которой при Т = 0 К электроны отсутствуют, называется свободной (на рисунке 1.1 это зона 1).
Ширина запрещенной зоны (зона 2 на рисунке 1.1) является важным параметром, определяющим свойства твердого тела. Вещества, у которых ширина запрещенной зоны D W £ 3 эВ, относятся к полупроводникам, а при D W > 3 эВ - к диэлектрикам. У металлов запрещенная зона отсутствует.
В полупроводниковой электронике широкое применение получили германий (D W = 0,72 эВ) и кремний (D W =1,12 эВ) - элементы 4-й группы периодической системы. На плоскости кристаллическую решетку этих элементов изображают так, как показано на рисунке 1.2, а. Здесь кружками с цифрой 4 обозначены атомы без валентных электронов, называемые атомным остатком с результирующим зарядом +4q (q - заряд электрона, равный 1,6× 10-19 Кл). При температуре абсолютного нуля (0 К) все электроны находятся на орбитах, энергия электронов на которых не превышает энергетических уровней валентной зоны. Свободных электронов нет, и полупроводник ведет себя, как диэлектрик.
При комнатной температуре часть электронов приобретает энергию, достаточную для разрыва ковалентной связи (рисунок 1.2, а). При разрыве ковалентной связи в валентной зоне появляется свободный энергетический уровень (рис. 1.2, б). Уход электрона из ковалентной связи сопровождается появлением в системе двух электрически связанных атомов единичного положительного заряда, получившего название дырки, и свободного электрона.
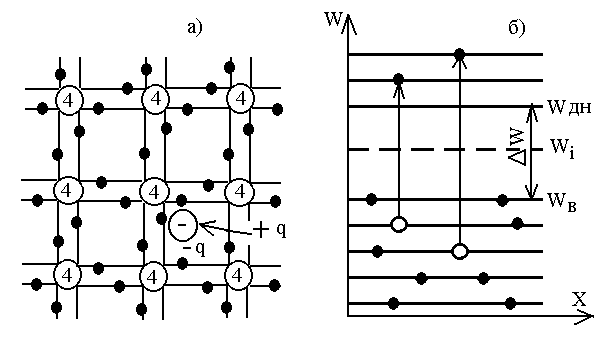
Рисунок 1.2. Условное обозначение кристаллической решетки (а) и энергетическая диаграмма (б) полупроводника с собственной электропроводностью.
Разрыв ковалентной связи на энергетической диаграмме характеризуется появлением в валентной зоне свободного энергетического уровня (см. рис. 1.2, б), на который может перейти электрон из соседней ковалентной связи. При таком перемещении первоначальный свободный энергетический уровень заполнится, но появится другой свободный энергетический уровень. Другими словами, заполнение дырки электроном из соседней ковалентной связи можно представить как перемещение дырки. Следовательно, дырку можно считать подвижным свободным носителем элементарного положительного заряда. Процесс образования пар электрон-дырка называют генерацией свободных носителей заряда. Очевидно, что количество их тем больше, чем выше температура и меньше ширина запрещенной зоны. Одновременно с процессом генерации протекает процесс рекомбинации носителей, при котором электрон восстанавливает ковалентную связь. Из-за процессов генерации и рекомбинации носителей зарядов при данной температуре устанавливается определенная концентрация электронов в зоне проводимости ni, и равная ей концентрация дырок pi, в валентной зоне.
Из курса физики известно, что
![]()
![]() (1.1)
(1.1)
где Wф - уровень Ферми, соответствующий уровню энергии, формальная вероятность заполнения которого равна 0,5 (формальная потому, что уровень Ферми находится в запрещенной зоне и фактически не может быть занят электронами; кривая распределения Ферми-Дирака, характеризующая вероятность нахождения электрона на том или ином энергетическом уровне, всегда симметрична относительно уровня Ферми); WДН - энергия, соответствующая "дну" зоны проводимости; WВ - энергия, соответствующая "потолку" валентной зоны; Аn, Ар - коэффициенты пропорциональности; k - постоянная Больцмана, равная 1,37× 10-23 Дж/град; Т- абсолютная температура, К.
В химически чистых полупроводниках уровень Ферми совпадает с серединой запрещенной зоны Wi, а также Аn = Ар = А. Поэтому можно записать:
![]() . (1.2)
. (1.2)
Из выражения (1.2) следует, что в чистом полупроводнике концентрации носителей зарядов зависят от ширины запрещенной зоны и при увеличении температуры возрастают приблизительно по экспоненциальному закону (температурные изменения А играют незначительную роль). Равенство концентраций ni и pi показывает, что такой полупроводник обладает одинаковыми электронной и дырочной электропроводностями и называется полупроводником с собственной электропроводностью.
1.1.2. Полупроводники с электронной электропроводностью
При введении в 4-валентный полупроводник примесных 5-валентных атомов (фосфора Р, сурьмы Sb) атомы примесей замещают основные атомы в узлах кристаллической решетки (рис. 1.3, а). Четыре электрона атома примеси вступают в связь с четырьмя валентными электронами соседних атомов основного полупроводника. Пятый валентный электрон слабо связан со своим атомом и при сообщении ему незначительной энергии, называемой энергией активации, отрывается от атома и становится свободным. Примеси, увеличивающие число свободных электронов, называют донорными или просто донорами. Доноры подбирают таким образом, чтобы их энергетические уровни Wд располагались в запрещенной зоне вблизи дна зоны проводимости основного полупроводника (рис. 1.3, б). Поскольку концентрация доноров в большинстве случаев не превышает 1015...1017 атомов в 1 см3, что составляет 10-4 % атомов основного вещества, то взаимодействие между атомами доноров отсутствует и их энергетические уровни не разбиваются на зоны.

Рисунок 1.3. Условное обозначение кристаллической решетки (а) и энергетическая диаграмма (б) полупроводника с электронной электропроводностью.
Малая энергия активизации примесей, равная 0,16 эВ для кремния и 0,01...0,13 эВ для германия, уже при комнатной температуре приводит к полной ионизации 5-валентных атомов примесей и появлению в зоне проводимости свободных электронов. Поскольку в этом случае появление свободных электронов в зоне проводимости не сопровождается одновременным увеличением дырок в валентной зоне, в таком полупроводнике концентрация электронов оказывается значительно больше концентрации дырок. Дырки в полупроводниках образуются только в результате разрыва ковалентных связей между атомами основного вещества.
Полупроводники, в которых концентрация свободных электронов в зоне проводимости превышает концентрацию дырок в валентной зоне, называются полупроводниками, с электронной электропроводностью или полупроводниками n-типа.
Подвижные носители заряда, преобладающие в полупроводнике, называют основными. Соответственно те носители заряда, которые находятся в меньшем количестве, называются неосновными для данного типа полупроводника. В полупроводнике n-типа основными носителями заряда являются электроны, а неосновными - дырки. В состоянии теплового равновесия в таком полупроводнике концентрации свободных электронов (![]() ) и дырок (
) и дырок (![]() ) определяются соотношениями:
) определяются соотношениями:
![]() ;
;![]() . (1.3)
. (1.3)
С учетом соотношений (1.1) выражения (1.3) можно представить в следующем виде:
![]() ; (1.4)
; (1.4)
![]() . (1.5)
. (1.5)
Из этих соотношений следует, что для полупроводника n-типа выполняется неравенство ![]() > >
> > ![]() .
.
Атомы 5-валентных примесей, "потерявшие" по одному электрону, превращаются в положительные ионы. В отличие от дырок положительные ионы прочно связаны с кристаллической решеткой основного полупроводника, являются неподвижными положительными зарядами и, следовательно, не могут принимать непосредственное участие в создании электрического тока в полупроводнике.
Если считать, что при комнатной температуре все атомы донорных примесей ионизированы (![]() = Nд,
= Nд, ![]() » 0), на основании выражения (1.4) можно записать:
» 0), на основании выражения (1.4) можно записать:
![]() , (1.6)
, (1.6)
где Nд - концентрация донорных атомов в полупроводнике.
Из соотношения (1.6) видно, что в полупроводниках n-типа уровень Ферми располагается в верхней половине запрещенной зоны, и тем ближе к зоне проводимости, чем больше концентрация доноров. При увеличении температуры уровень Ферми смещается к середине запрещенной зоны за счет ионизации основных атомов полупроводника.
Повышение концентрации электронов в данном полупроводнике значительно снижает его удельное сопротивление. Например, чистый кремний имеет r = 2× 103 Ом× м, а легированный фосфором - (0,25...0,4)× 102 Ом× м.
1.1.3. Полупроводники с дырочной электропроводностью
Если в кристалле 4-валентного элемента часть атомов замещена атомами 3-валентного элемента (галлия Ga, индия In), то для образования четырех ковалентных связей у примесного атома не хватает одного электрона (рис. 1.4, а). Этот электрон может быть получен от атома основного элемента полупроводника за счет разрыва ковалентной связи. Разрыв связи приводит к появлению дырки, так как сопровождается образованием свободного уровня в валентной зоне. Примеси, захватывающие электроны из валентной зоны, называют акцепторными или акцепторами. Энергия активизации акцепторов составляет для германия 0,01...0,012 эВ и для кремния 0,04...0,16 эВ, что значительно меньше ширины запрещенной зоны беспримесного полупроводника. Следовательно, энергетические уровни примесных атомов располагаются вблизи валентной зоны (рис. 1.4, б).

Рисунок 1.4. Условное изображение кристаллической решетки (а) и энергетическая диаграмма (б) полупроводника с дырочной электропроводностью.
Ввиду малого значения энергии активизации акцепторов уже при комнатной температуре электроны из валентной зоны переходят на уровни акцепторов. Эти электроны, превращая примесные атомы в отрицательные ионы, теряют способность перемещаться по кристаллической решетке, а образовавшиеся при этом дырки могут участвовать в создании электрического тока.
За счет ионизации атомов исходного материала из валентной зоны часть электронов попадает в зону проводимости. Однако электронов в зоне проводимости значительно меньше, чем дырок в валентной зоне. Поэтому дырки в таких полупроводниках являются основными, а электроны - неосновными подвижными носителями заряда. Такие полупроводники носят название полупроводников с дырочной электропроводностью или полупроводников р-типа. В состоянии теплового равновесия концентрация дырок в полупроводнике р-типа (![]() ) и свободных электронов (
) и свободных электронов (![]() ) определяется из соотношений:
) определяется из соотношений:
![]() ; (1.7)
; (1.7)
![]() (1.8)
(1.8)
Из уравнений (1.7) и (1.8) следует, что для полупроводника р-типа выполняется неравенство ![]() > >
> > ![]() .
.
Если считать, что при комнатной температуре все акцепторные атомы ионизированы, т. е. ![]() =0, то на основании соотношения можно записать:
=0, то на основании соотношения можно записать:
![]() , (1.9)
, (1.9)
где Na — концентрация акцепторных атомов в полупроводнике.
Соотношение (1.9) показывает, что уровень Ферми в полупроводнике р-типа располагается в нижней половине запрещенной зоны, так как Na >> ni, и при повышении температуры смещается к середине запрещенной зоны за счет ионизации атомов основного полупроводника.
Кроме того, на основании уравнений (1.4), (1.5), (1.7) и (1.8) можно записать следующее выражение:
![]() (1.10)
(1.10)
которое показывает, что введение в полупроводник примесей приводит к увеличению концентрации одних носителей заряда и пропорциональному уменьшению концентрации других носителей заряда за счет роста вероятности их рекомбинации.
1.2. Токи в полупроводниках
1.2.1. Дрейфовый ток
В полупроводниках свободные электроны и дырки находятся в состоянии хаотического движения. Поэтому, если выбрать произвольное сечение внутри объема полупроводника и подсчитать число носителей заряда, проходящих через это сечение за единицу времени слева направо и справа налево, значения этих чисел окажутся одинаковыми. Это означает, что электрический ток в данном объеме полупроводника отсутствует.
При помещении полупроводника в электрическое поле напряженностью Е на хаотическое движение носителей зарядов накладывается составляющая направленного движения. Направленное движение носителей зарядов в электрическом поле обусловливает появление тока, называемого дрейфовым. Из-за столкновения носителей зарядов с атомами кристаллической решетки их движение в направлении действия электрического поля прерывисто и характеризуется подвижностью m. Подвижность равна средней скорости ![]() , приобретаемой носителями заряда в направлении действия электрического поля напряженностью Е = 1 В/м, т. е.
, приобретаемой носителями заряда в направлении действия электрического поля напряженностью Е = 1 В/м, т. е.
![]() . (1.11)
. (1.11)
Подвижность носителей зарядов зависит от механизма их рассеивания в кристаллической решетке. Исследования показывают, что подвижности электронов m n и дырок m p имеют различное значение (m n > m p) и определяются температурой и концентрацией примесей. Увеличение температуры приводит к уменьшению подвижности, что зависит от числа столкновений носителей зарядов в единицу времени.
Плотность тока в полупроводнике, обусловленного дрейфом свободных электронов под действием внешнего электрического поля со средней скоростью ![]() , определяется выражением
, определяется выражением ![]() .
.
Перемещение (дрейф) дырок в валентной зоне со средней скоростью ![]() создает в полупроводнике дырочный ток, плотность которого
создает в полупроводнике дырочный ток, плотность которого ![]() . Следовательно, полная плотность тока в полупроводнике содержит электронную jn и дырочную jр составляющие и равна их сумме (n и p — концентрации соответственно электронов и дырок).
. Следовательно, полная плотность тока в полупроводнике содержит электронную jn и дырочную jр составляющие и равна их сумме (n и p — концентрации соответственно электронов и дырок).
Подставляя в выражение для плотности тока соотношение для средней скорости электронов и дырок (1.11), получаем
![]() . (1.12)
. (1.12)
Если сравнить выражение (1.12) с законом Ома j = d Е, то удельная электропроводность полупроводника определяется соотношением
![]() .
.
У полупроводника с собственной электропроводностью концентрация электронов равна концентрации дырок (ni = pi), и его удельная электропроводность определяется выражением
![]() .
.
В полупроводнике n-типа ![]() >
> ![]() , и его удельная электропроводность с достаточной степенью точности может быть определена выражением
, и его удельная электропроводность с достаточной степенью точности может быть определена выражением
![]() .
.
В полупроводнике р-типа ![]() >
> ![]() , и удельная электропроводность такого полупроводника
, и удельная электропроводность такого полупроводника
![]()
В области высоких температур концентрация электронов и дырок значительно возрастает за счет разрыва ковалентных связей и, несмотря на уменьшение их подвижности, электропроводность полупроводника увеличивается по экспоненциальному закону.
1.2.2. Диффузионный ток
Кроме теплового возбуждения, приводящего к возникновению равновесной концентрации зарядов, равномерно распределенных по объему полупроводника, обогащение полупроводника электронами до концентрации np и дырками до концентрации pn может осуществляться его освещением, облучением потоком заряжённых частиц, введением их через контакт (инжекцией) и т. д. В этом случае энергия возбудителя передается непосредственно носителям заряда и тепловая энергия кристаллической решетки остается практически постоянной. Следовательно, избыточные носители заряда не находятся в тепловом равновесии с решеткой и поэтому называются неравновесными. В отличие от равновесных они могут неравномерно распределяться по объему полупроводника.
После прекращения действия возбудителя за счет рекомбинации электронов и дырок концентрация избыточных носителей быстро убывает и достигает равновесного значения.
Скорость рекомбинации неравновесных носителей пропорциональна избыточной концентрации дырок (pn - ![]() ) или электронов (np -
) или электронов (np - ![]() ):
):
![]() ;
; ![]() ,
,
где t p - время жизни дырок; t n - время жизни электронов. За время жизни концентрация неравновесных носителей уменьшается в 2,7 раза. Время жизни избыточных носителей составляет 0,01...0,001 с.
Носители зарядов рекомбинируют в объеме полупроводника и на его поверхности. Особенно эффективной является рекомбинация через центры захвата. Она заключается в следующем.
В запрещенной зоне полупроводника могут появиться локальные энергетические уровни, которые образуются примесными атомами и различными дефектами кристаллической решетки.
Глубокие локальные уровни, находящиеся вблизи середины запрещенной зоны, являются эффективными центрами рекомбинации. На локальный уровень из зоны проводимости может переходить электрон (рис. 1.5).
Вероятность встречи дырки с "неподвижным" электроном, расположенным на глубинном локальном уровне, значительно выше вероятности встречи ее с подвижным электроном.
Неравномерное распределение неравновесных носителей зарядов сопровождается их диффузией в сторону меньшей концентрации. Это движение носителей зарядов обусловливает прохождение электрического тока, называемого диффузионным.
Рассмотрим одномерный случай. Пусть в полупроводнике концентрации электронов n(x) и дырок p(x) являются функциями координаты. Это приведет к диффузионному движению дырок и электронов из области с большей их концентрацией в область с меньшей концентрацией.
Диффузионное движение носителей зарядов обусловливает прохождение диффузионного тока электронов и дырок, плотности которых определяются из соотношений:
![]() ; (1.13)
; (1.13)
![]() ; (1.14)
; (1.14)
где dn(x)/dx, dp{x)/dx - градиенты концентраций электронов и дырок; Dn, Dp - коэффициенты диффузии электронов и дырок.
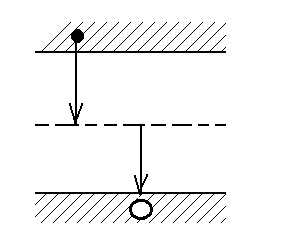
Рис. 1.5. Локальный уровень в запрещенной зоне.
Градиент концентрации характеризует степень неравномерности распределения зарядов (электронов и дырок) в полупроводнике вдоль какого-то выбранного направления (в данном случае вдоль оси x). Коэффициенты диффузии показывают количество носителей заряда, пересекающих в единицу времени единичную площадку, перпендикулярную к выбранному направлению, при градиенте концентрации в этом направлении, равном единице. Коэффициенты диффузии связаны с подвижностями носителей зарядов соотношениями Эйнштейна:
![]() ;
; ![]() .
.
Знак "минус" в выражении (1.14) означает противоположную направленность электрических токов в полупроводнике при диффузионном движении электронов и дырок в сторону уменьшения их концентраций.
Если в полупроводнике существует и электрическое поле, и градиент концентрации носителей, проходящий ток будет иметь дрейфовую и диффузионную составляющие. В таком случае плотности токов рассчитываются по следующим уравнениям:
![]() ;
; ![]() .
.
1.3. Контактные явления
1.3.1. Электронно-дырочный переход в состоянии равновесия
Принцип действия большинства полупроводниковых приборов основан на физических явлениях, происходящих в области контакта твердых тел. При этом преимущественно используются контакты: полупроводник-полупроводник; металл-полупроводник; металл-диэлектрик-полупроводник.
Если переход создается между полупроводниками n-типа и p-типа, то его называют электронно-дырочным или p-n переходом.
Электронно-дырочный переход создается в одном кристалле полупроводника с использованием сложных и разнообразных технологических операций.
Рассмотрим p-n переход, в котором концентрации доноров Nд и акцепторов Na изменяются скачком на границе раздела (рис. 1.6, а). Такой p-n переход называют резким. Равновесная концентрация дырок в p-области (![]() ) значительно превышает их концентрацию в n-области (
) значительно превышает их концентрацию в n-области (![]() ). Аналогично для электронов выполняется условие
). Аналогично для электронов выполняется условие ![]() >
> ![]() . Неравномерное распределение концентраций одноименных носителей зарядов в кристалле (рис. 1.6, б) приводит к возникновению диффузии электронов из n-области в p-область и дырок из p-области в n-область. Такое движение зарядов создает диффузионный ток электронов и дырок. С учетом выражений (1.13) и (1.14) плотность полного диффузионного тока, проходящего через границу раздела, определится суммой
. Неравномерное распределение концентраций одноименных носителей зарядов в кристалле (рис. 1.6, б) приводит к возникновению диффузии электронов из n-области в p-область и дырок из p-области в n-область. Такое движение зарядов создает диффузионный ток электронов и дырок. С учетом выражений (1.13) и (1.14) плотность полного диффузионного тока, проходящего через границу раздела, определится суммой
![]() .
.
Электроны и дырки, переходя через контакт (благодаря диффузии), оставляют в приконтактной области дырочного полупроводника нескомпенсированный заряд отрицательных ионов акцепторных примесей, а в электронном полупроводнике - нескомпенсированный заряд положительных донорных ионов (рис. 1.6, в). Таким образом, электронный полупроводник заряжается положительно, а дырочный - отрицательно. Между областями с различными типами электропроводности возникает диффузионное электрическое поле напряженностью Eдиф (рис. 1.6, г), созданное двумя слоями объемных зарядов. Этому полю соответствует разность потенциалов Uк между n- и p-областями, называемая контактной (рис. 1.6, г). За пределами области объемного заряда полупроводниковые области п- и р-типа остаются электрически нейтральными.
Диффузионное электрическое поле является тормозящим для основных носителей заряда и ускоряющим для неосновных. Электроны p-области и дырки n-области, совершая тепловое движение, попадают в пределы диффузионного электрического поля, увлекаются им и перебрасываются в противоположные области, образуя ток дрейфа, или ток проводимости.
Выведение носителей заряда из области полупроводника, где они являются неосновными, через электронно-дырочный переход ускоряющим электрическим полем называют экстракцией носителей заряда.
Используя выражение (1.12) и учитывая, что Е = -dU/dx, определяем плотность полного дрейфового тока через границу раздела p- и n-областей:
![]() .
.
Так как через изолированный полупроводник ток проходить не должен, между диффузионным и дрейфовым токами устанавливается динамическое равновесие:
![]() . (1.15)
. (1.15)
Приконтактную область, где имеется диффузионное электрическое поле, называют p-n переходом.
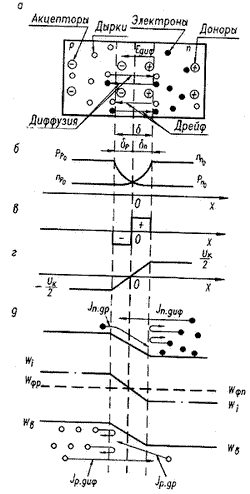
Рисунок 1.6. Равновесное состояние p-n перехода.
Поскольку потенциальная энергия электрона и потенциал связаны соотношением W = -qU, образование нескомпенсированных объемных зарядов вызывает понижение энергетических уровней n-области и повышение энергетических уровней р-области. Смещение энергетических диаграмм прекратится, когда уровни Ферми W фn и W фp совпадут (рис. 1.6, д). При этом на границе раздела (x = 0) уровень Ферми проходит через середину запрещенной зоны. Это означает, что в плоскости сечения x = 0 полупроводник характеризуется собственной электропроводностью и обладает по сравнению с остальным объемом повышенным сопротивлением. В связи с этим его называют запирающим слоем или областью объемного заряда.
Совпадение уровней Ферми n- и p-областей соответствует установлению динамического равновесия между областями и возникновению между ними потенциального барьера Uk для диффузионного перемещения через p-n переход электронов n-области и дырок p-области.
Из рис. 1.6, д следует, что потенциальный барьер
![]() .
.
Подстановка в это выражение результатов логарифмирования соотношений (1.4), (1.7) позволяет получить следующее равенство:
![]() .
.
Если обозначить j т = kT/q и учесть уравнение (1.10), то можно записать:
![]() ; (1.16)
; (1.16)
![]() . (1.17)
. (1.17)
Из уравнений (1.16) и (1.17) следует:
![]() ;
; ![]() . (1.18)
. (1.18)
При комнатной температуре (Т = 300 К) j т » 0,026 В.
Таким образом, контактная разность потенциалов зависит от отношения концентраций носителей зарядов одного знака в р- и n-областях полупроводника.
Другим важным параметром p-n перехода является его ширина, обозначаемая d = d p + d n.
Ширину запирающего слоя d можно найти, решив уравнения Пуассона для n-области и p-области:
![]() ; (1.19)
; (1.19)
![]() . (1.20)
. (1.20)
Решения уравнений (1.19) и (1.20) при граничных условиях
![]() ;
; ![]()
![]() ;
; ![]()
имеют вид:
![]() для -d p < x < 0;
для -d p < x < 0;
![]() для 0 < x <d n; (1.21)
для 0 < x <d n; (1.21)
В точке x = 0 оба решения должны давать одинаковые значения j и ![]() . Приравняв
. Приравняв  и
и ![]() , можно записать:
, можно записать:
![]() . (1.22)
. (1.22)
Из равенства (1.22) видно, что ширина слоев объемных зарядов в n- и p-областях обратно пропорциональна концентрациям примесей и в несимметричном переходе запирающий слой расширяется в область с меньшей концентрацией примесей.
На основании равенства (1.22) можно записать:
![]() ;
;![]() , (1.23)
, (1.23)
где d = d n + d р.
Приравнивая правые части уравнений (1.21) и учитывая соотношения (1.23), при x = 0 получаем
![]() .
.
На основании этого выражения формулу для определения ширины запирающего слоя p-n перехода можно записать в следующем виде:
 . (1.24)
. (1.24)
Из соотношения (1.24) видно, что на ширину запирающего слоя существенное влияние оказывает концентрация примесных атомов. Увеличение концентрации примесных атомов сужает запирающий слой, а уменьшение расширяет его. Это часто используется для придания полупроводниковым приборам требуемых свойств.
При использовании p-n перехода в полупроводниковых приборах к нему подключается внешнее напряжение. Величина и полярность этого внешнего напряжения определяют электрический ток, проходящий через p-n переход.
Если положительный полюс источника питания подключается к р-области, а отрицательный полюс - к n-области, то включение p-n перехода называют прямым. При изменении указанной полярности источника питания включение p-n перехода называют обратным.
1.3.2. Прямое включение p-n перехода
Прямое включение p-n перехода показано на рис. 1.7. Поскольку сопротивление p-n перехода значительно превышает сопротивление нейтральных p- и n-областей, внешнее напряжение Uпр почти полностью падает на этом переходе.
Прямое напряжение создает в переходе внешнее электрическое поле, направленное навстречу диффузионному.
Напряженность результирующего поля падает, и уровни Ферми смещаются таким образом, что потенциальный барьер уменьшается до Uк - Uпр. Это сопровождается сужением запирающего слоя, ширина которого может быть найдена из соотношения (1.24) подстановкой вместо Uк величины Uк - Uпр:
 .
.
В результате снижения потенциального барьера большее количество основных носителей зарядов получает возможность диффузионно переходить в соседнюю область, что сопровождается ростом тока диффузии. Ток дрейфа при этом не изменится, поскольку он зависит от количества неосновных носителей, появляющихся на границах p-n перехода. Это количество зависит только от концентрации примесей в полупроводнике и температуры.
Увеличение диффузионной составляющей тока через p-n переход при неизменной дрейфовой составляющей приводит к нарушению термодинамического равновесия, устанавливаемого выражением (1.15). Через переход будет проходить результирующий ток, определяемый диффузионной составляющей.
Дополнительная диффузия носителей зарядов приводит к тому, что на границе p-n перехода повышаются концентрации дырок в области n-типа до некоторого значения ![]() и электронов в p-области до значения
и электронов в p-области до значения ![]() . Повышение концентраций неосновных носителей в p- и n-областях вследствие влияния внешнего напряжения, приложенного к электронно-дырочному переходу, получило название инжекции неосновных носителей. Область, из которой происходит инжекция, называют эмиттером, а область, в которую осуществляется инжекция, — базой.
. Повышение концентраций неосновных носителей в p- и n-областях вследствие влияния внешнего напряжения, приложенного к электронно-дырочному переходу, получило название инжекции неосновных носителей. Область, из которой происходит инжекция, называют эмиттером, а область, в которую осуществляется инжекция, — базой.
Поскольку при прямом включении p-n перехода потенциальный барьер уменьшается, концентрации неосновных носителей на границах p-n перехода могут быть рассчитаны по формулам (1.18) при замене Uк величиной Uк - Uпр. Тогда:
![]() ; (1.25)
; (1.25)
![]() . (1.26)
. (1.26)
Из выражений (1.25) и (1.26) следует, что на границах p-n перехода под действием прямого напряжения Uпр происходит увеличение концентраций неосновных носителей.
Неравновесные неосновные носители зарядов диффундируют в глубь полупроводника и нарушают его электронейтральность. Восстановление нейтрального состояния полупроводников происходит за счет поступления носителей зарядов от внешнего источника. Это является причиной возникновения тока во внешней цепи, называемого прямым и обозначаемого Iпр.

Рисунок 1.7. Прямое включение p-n перехода.
Концентрации неосновных носителей в нейтральной области полупроводника зависят от координаты x. Закон их распределения может быть найден путем решения уравнения непрерывности для установившегося состояния, т. е. состояния, при котором концентрация неосновных носителей не изменяется во времени. Этому условию соответствуют уравнения непрерывности, которые при Е = 0 записываются в следующем виде:
![]() ; (1.27)
; (1.27)
![]() ; (1.28)
; (1.28)
где ![]() - диффузионная длина дырок в n-области;
- диффузионная длина дырок в n-области; ![]() - диффузионная длина электронов в p-области.
- диффузионная длина электронов в p-области.
Решения уравнений непрерывности (1.27) и (1.28) для нейтральной области полупроводников (начало отсчета координаты совпадает с границами p-n перехода) при очевидных из рис. 1.7 начальных условиях и с учетом соотношений (1.25) и (1.26) имеют вид:
![]() ; (1.29)
; (1.29)
![]() . (1.30)
. (1.30)
Таким образом, на границе запирающего слоя (x = 0) за счет инжекции концентрация носителей повышается и достигает следующих значений:
![]() ;
;
![]() .
.
Уравнения (1.29) и (1.30) показывают, что в неравновесном состоянии при удалении от p-n перехода концентрации неосновных носителей зарядов вследствие рекомбинации убывают по экспоненциальному закону от значений ![]() и
и ![]() до
до ![]() и
и ![]() .
.
При x = Lp и x = Ln концентрации неосновных носителей уменьшаются в 2,7 раза. Таким образом, диффузионная длина — это расстояние, на котором концентрация неосновных носителей в неравновесном состоянии уменьшается в е раз.
1.3.3. Обратное включение p-n-перехода
При включении p-n перехода в обратном направлении (рис. 1.8) внешнее обратное напряжение Uобр создает электрическое поле, совпадающее по направлению с диффузионным, что приводит к росту потенциального барьера на величину Uобр и увеличению относительного смещения энергетических диаграмм на q(Uk + Uобр). Это сопровождается увеличением ширины запирающего слоя, которая может быть найдена из соотношения (1.24) подстановкой вместо Uk величины Uk + Uобр.
 . (1.31)
. (1.31)
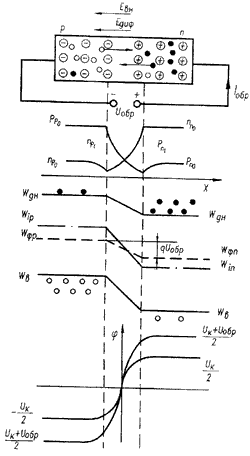
Рисунок 1.8. Обратное включение p-n перехода.
Возрастание потенциального барьера уменьшает диффузионные токи основных носителей (т. е. меньшее их количество преодолеет возросший потенциальный барьер). Для неосновных носителей поле в p-n переходе остается ускоряющим, и поэтому дрейфовый ток, как было показано в п. 1.3.2, не изменится.
Уменьшение диффузионного тока приведет к нарушению условия равновесия, устанавливаемого выражением (1.15). Через переход будет проходить результирующий ток, определяемый в основном током дрейфа неосновных носителей.
Концентрация неосновных носителей у границ p-n перехода вследствие уменьшения диффузионного перемещения основных носителей уменьшится до некоторых значений ![]() и
и ![]() . По мере удаления от p-n перехода концентрация неосновных носителей будет возрастать до равновесной. Значение концентрации неосновных носителей заряда на любом удалении x от границ p-n перехода можно рассчитать по следующим формулам, полученным при решении уравнения непрерывности для обратного, включения p-n перехода:
. По мере удаления от p-n перехода концентрация неосновных носителей будет возрастать до равновесной. Значение концентрации неосновных носителей заряда на любом удалении x от границ p-n перехода можно рассчитать по следующим формулам, полученным при решении уравнения непрерывности для обратного, включения p-n перехода:
![]() ; (1.32)
; (1.32)
![]() . (1.33)
. (1.33)
1.3.4. Теоретическая вольт-амперная характеристика p-n перехода
Вольт-амперная характеристика представляет собой график зависимости тока во внешней цепи p-n перехода от значения и полярности напряжения, прикладываемого к нему. Эта зависимость может быть получена экспериментально или рассчитана на основании уравнения вольт-амперной характеристики.
При включении p-n перехода в прямом направлении в результате инжекции возникает прямой диффузионный ток.
Уравнения для плотности электронной и дырочной составляющих прямого тока получаются подстановкой соотношений (1.29) и (1.30) в (1.13) и (1.14) и, записываются в следующем виде:
![]() ;
;
 .
.
Плотность прямого тока, проходящего через p-n переход, можно определить как сумму jпр = jn диф + jp диф, не изменяющуюся при изменении координаты х. Если считать, что в запирающем слое отсутствуют генерация и рекомбинация носителей зарядов, то плотность прямого тока, определяемая на границах p-n перехода (при x = 0),
![]() . (1.34)
. (1.34)
Включение p-n перехода в обратном направлении приводит к обеднению приконтактной области неосновными носителями и появлению градиента их концентрации. Градиент концентрации является причиной возникновения диффузионного тока неосновных носителей.
На основании соотношений (1.13), (1.14) и (1.32), (1.33) выражение для расчета плотности обратного тока может быть записано в виде
 . (1.35)
. (1.35)
Объединяя выражения (1.34) и (1.35), можно записать уравнение для плотности тока в общем виде:
![]() , (1.36)
, (1.36)
где
 .
.
Величину js называют плотностью тока насыщения. Умножив правую и левую части выражения (1.36) на площадь П p-n перехода, получим уравнение теоретической вольт-амперной характеристики:
![]() , (1.37)
, (1.37)
где Уд - ток насыщения. В это уравнение напряжение U подставляется со знаком "плюс" при включении p-n перехода в прямом направлении и со знаком "минус" при обратном включении.
Уравнение (1.37) позволяет рассчитать теоретическую вольт-амперную характеристику тонкого электронно-дырочного перехода, в котором отсутствуют генерация и рекомбинация носителей зарядов.
Теоретическая вольт-амперная характеристика p-n перехода, построенная на основании уравнения (1.37), приведена на рис. 1.9. При увеличении обратного напряжения ток через p-n переход стремится к предельному значению js, которого достигает при обратном напряжении примерно 0,1...0,2 В.
На основании соотношений (1.2), (1.5), (1.8) и (1.10), считая, что все атомы примесей ионизированы, т. е. ![]() = Na, для области рабочих температур можно записать:
= Na, для области рабочих температур можно записать:
![]() . (1.38)
. (1.38)
Из соотношения (1.38) видно, что чем больше ширина запрещенной зоны полупроводника и концентрация примесей доноров и акцепторов, тем меньше ток насыщения, а с увеличением температуры ток насыщения растет по экспоненциальному закону.
Процессы генерации и рекомбинации носителей в запирающем слое оказывают существенное влияние на вид вольт-амперной характеристики. В отсутствие внешнего напряжения между процессами генерации и рекомбинации устанавливается равновесие. При приложении к p-n переходу обратного напряжения дырки и электроны, образующиеся в результате генерации, выводятся полем запирающего слоя. Это приводит к возникновению дополнительного тока генерации Iген, совпадающего с обратным током p-n перехода. Можно показать, что при ![]() =
= ![]() , t n = t р = t 0 и Ln = Lp = L0 справедливо соотношение
, t n = t р = t 0 и Ln = Lp = L0 справедливо соотношение
![]() , (1.39)
, (1.39)
где d 0 - толщина запирающего слоя.

Рисунок 1.9. Теоретическая вольт-амперная характеристика p-n перехода.
Из выражения (1.39) видно, что генерационная составляющая обратного тока растет при увеличении ширины запрещенной зоны полупроводника, так как при этом уменьшается значение ni, а также при увеличении концентрации примесей, при которой возрастает ![]() . Например, при одинаковых значениях d 0 и L0 для германия ni = 2,5× 1013 см-3 (D W = 0,72 эВ) и Iген = 0,1 Is, а для кремния ni = 6,8× 1010 см-3 (D W = 1,12 эВ) и Iген = 3000IS,.
. Например, при одинаковых значениях d 0 и L0 для германия ni = 2,5× 1013 см-3 (D W = 0,72 эВ) и Iген = 0,1 Is, а для кремния ni = 6,8× 1010 см-3 (D W = 1,12 эВ) и Iген = 3000IS,.
Таким образом, если в германиевых p-n переходах током генерации можно пренебречь, то в кремниевых p-n переходах он является основной составляющей обратного тока. Поэтому на вольт-амперных характеристиках кремниевых p-n переходов нет выраженного участка насыщения.
1.3.5. Реальная вольт-амперная характеристика p-n перехода
При выводе уравнения (1.37) не учитывались такие явления, как термогенерация носителей в запирающем слое перехода, поверхностные утечки тока, падение напряжения на сопротивлении нейтральных областей полупроводника, а также явления пробоя при определенных обратных напряжениях. Поэтому экспериментальная вольт-амперная характеристика p-n перехода (кривая 2 на рис. 1.10) отличается от теоретической (кривая 1).
При обратном включении p-n перехода отличия обусловлены генерацией носителей зарядов и пробоем p-n перехода. Количество генерируемых носителей пропорционально объему запирающего слоя, который зависит от ширины p-n перехода. Поскольку ширина запирающего слоя пропорциональна ![]() , ток генерации будет расти при увеличении обратного напряжения. Поэтому на реальной характеристике при увеличении обратного напряжения до определенного значения наблюдается небольшой рост обратного тока. Возрастанию обратного тока способствуют также токи утечки.
, ток генерации будет расти при увеличении обратного напряжения. Поэтому на реальной характеристике при увеличении обратного напряжения до определенного значения наблюдается небольшой рост обратного тока. Возрастанию обратного тока способствуют также токи утечки.

Рисунок 1.10. Отличие реальной вольт-амперной характеристики p-n перехода от теоретеческой.
При некотором обратном напряжении наблюдается резкое возрастание обратного тока. Это явление называют пробоем p-n перехода. Существуют три вида пробоя: туннельный, лавинный и тепловой. Туннельный и лавинный пробои представляют собой разновидности электрического пробоя и связаны с увеличением напряженности электрического поля в переходе. Тепловой пробой определяется перегревом перехода.
Туннельный пробой обусловлен прямым переходом электронов из валентной зоны одного полупроводника в зону проводимости другого, что становится возможным, если напряженность электрического поля в p-n переходе из кремния достигает значения 4× 105 В/см, а из германия -2× 105 В/см. Такая большая напряженность электрического поля возможна при высокой концентрации примесей в p- и n-областях, когда толщина p-n перехода становится весьма малой (см. формулу (1.31)). Под действием сильного электрического поля валентные электроны вырываются из связей. При этом образуются парные заряды электрон-дырка, увеличивающие обратный ток через переход. На рис. 1.10 кривая 5 представляет собой обратную ветвь вольт-амперной характеристики перехода, соответствующую туннельному пробою.
В широких p-n переходах, образованных полупроводниками с меньшей концентрацией примесей, вероятность туннельного просачивания электронов уменьшается и более вероятным становится лавинный пробой. Он возникает тогда, когда длина свободного пробега электрона в полупроводнике значительно меньше толщины p-n перехода. Если за время свободного пробега электроны накапливают кинетическую энергию, достаточную для ионизации атомов в p-n переходе, наступает ударная ионизация, сопровождающаяся лавинным размножением носителей зарядов. Образовавшиеся в результате ударной ионизации свободные носители зарядов увеличивают обратный ток перехода. Увеличение обратного тока характеризуется коэффициентом лавинного умножения М:
![]() , (1.40)
, (1.40)
где Uпроб - напряжение начала пробоя; m зависит от материала полупроводника. На рис 1.10 лавинному пробою соответствует кривая 4.
Тепловой пробой обусловлен значительным ростом количества носителей зарядов в p-n переходе за счет нарушения теплового режима. Подводимая к p-n переходу мощность Рподв = IобрUобр расходуется на его нагрев.
Выделяющаяся в запирающем слое теплота отводится преимущественно за счет теплопроводности. Отводимая от p-n перехода мощность Ротв пропорциональна разности температур перехода Tпер и окружающей среды Токр:
![]() ,
,
где Rт - тепловое сопротивление, К/Вт, определяющее перепад температур, необходимый для отвода 1 Вт мощности от p-n перехода в окружающую среду.
При плохих условиях отвода теплоты от перехода возможен его разогрев до температуры, при которой происходит тепловая ионизация атомов. Образующиеся при этом носители заряда увеличивают обратный ток, что приводит к дальнейшему разогреву перехода. В результате такого нарастающего процесса p-n переход недопустимо разогревается и возникает тепловой пробой, характеризующийся разрушением кристалла (кривая 3).
Увеличение числа носителей зарядов при нагреве p-n перехода приводит к уменьшению его сопротивления и выделяемого на нем напряжения. Вследствие этого на обратной ветви вольт-амперной характеристики при тепловом пробое появляется участок с отрицательным дифференциальным сопротивлением (участок АВ на рис. 1.10).
Отличия реальной характеристики от теоретической на прямой ветви в основном обусловлены сопротивлением электронной и дырочной областей за пределами запирающего слоя (r1).
Если сопротивление запирающего слоя обозначить rд, то кристалл полупроводника с запирающим слоем можно представить в виде последовательного соединения резисторов rд и r1 (рис. 1.11).
При прохождении тока Iпр на сопротивлении r1 падает часть напряжения внешнего источника и на запирающем слое действует напряжение Uпер = Uпр× Iпрr1. Уравнение вольт-амперной характеристики в этом случае может быть записано в следующем неявном виде:
![]() .
.
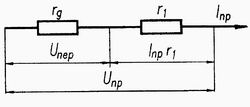
Рисунок 1.11. Упрощенная эквивалентная схема p-n перехода с распределенным сопротивлением проводникам.
Поскольку Uпер < Uпр реальная характеристика идет ниже теоретической. Когда напряжение на запирающем слое становится равным контактной разности потенциалов, запирающий слой исчезает и дальнейшее увеличение тока ограничивается распределенным сопротивлением полупроводников p- и n-типа. Таким образом, в точке С при Uпр = Uk вольт-амперная характеристика переходит в прямую линию.
1.3.6. Емкости p-n перехода
Изменение внешнего напряжения dU на p-n переходе приводит к изменению накопленного в нем заряда dQ. Поэтому p-n переход ведет себя подобно конденсатору, емкость которого С = dQ/ dU.
В зависимости от физической природы изменяющегося заряда различают емкости зарядную (барьерную) и диффузионную.
Зарядная (барьерная) емкость определяется изменением нескомпенсированного заряда ионов при изменении ширины запирающего слоя под воздействием внешнего обратного напряжения. Поэтому идеальный электронно-дырочный переход можно рассматривать как плоский конденсатор, емкость которого определяется соотношением
![]() , (1.41)
, (1.41)
где П, δ - соответственно площадь и толщина p-n перехода.
Из соотношений (1.41) и (1.31) следует
 .
.
В общем случае зависимость зарядной емкости от приложенного к p-n переходу обратного напряжения выражается формулой
 ,
,
где C0 — емкость p-n перехода при Uобр = 0; g - коэффициент, зависящий от типа p-n перехода (для резких p-n переходов g = 1/2, а для плавных g = 1/3).
Зарядная емкость увеличивается с ростом Na и Nд, а также с уменьшением обратного напряжения. Характер зависимости С = f(Uобр) показан на рис. 1.12.
Рассмотрим диффузионную емкость. При увеличении внешнего напряжения, приложенного к p-n переходу в прямом направлении, растет концентрация инжектированных носителей вблизи границ перехода, что приводит к изменению количества заряда, обусловленного неосновными носителями в p- и n-областях. Это можно рассматривать как проявление некоторой емкости. Поскольку она зависит от изменения диффузионной составляющей тока, ее называют диффузионной. Диффузионная емкость представляет собой отношение приращения инжекционного заряда dQинж к вызвавшему его изменению напряжения dUпрб т. е.
![]() .
.

Рисунок 1.12. Зависимость зарядной емкости p-n перехода от обратного напряжения.
Воспользовавшись уравнением (1.30), можно определить заряд инжектированных носителей, например дырок в n-области:
 .
.
Тогда диффузионная емкость, обусловленная изменением общего заряда неравновесных дырок в n-области, определится по формуле
![]() .
.
Аналогично для диффузионной емкости, обусловленной инжекцией электронов в p-область,
 .
.
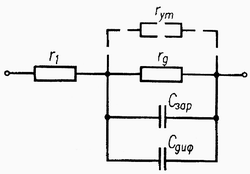
Рисунок 1.13. Эквивалентная схема p-n перехода.
Общая диффузионная емкость
![]() .
.
Полная емкость p-n перехода определяется суммой зарядной и диффузионной емкостей:
![]() .
.
При включении p-n перехода в прямом направлении преобладает диффузионная емкость, а при включении в обратном направлении - зарядная.
На рис. 1.13 приведена эквивалентная схема p-n перехода по переменному току. Схема содержит дифференциальное сопротивление p-n перехода rд, диффузионную емкость Сдиф, зарядную емкость Сзар и сопротивление объема p- и n-областей r1. На основании уравнения (1.37) можно записать:
![]() .
.
Если при прямом включении p-n перехода Uпр >> j т, то:
![]() ;
; ![]() .
.
При комнатной температуре
![]() ;(1.42)
;(1.42)
(в соотношении (1.42) значение тока подставляется в амперах). Сопротивление утечки rут учитывает возможность прохождения тока по поверхности кристалла из-за несовершенства его структуры. При прямом включении p-n перехода Сзар << Сдиф, дифференциальное сопротивление rд.пр мало и соизмеримо с г1, поэтому эквивалентная схема принимает вид, показанный на рис. 1.14, а.
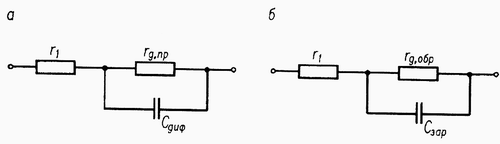
Рисунок 1.14. Упрощенные эквивалентные схемы p-n перехода.
При обратном смещении rд.обр >> r1, Сзар >> Сдиф и эквивалентная схема имеет вид, показанный на рис. 1.14, б.
1.4. Разновидности электрических переходов
1.4.1. Гетеропереходы
Гетеропереход образуется двумя полупроводниками, различающимися шириной запрещенной зоны. Параметры кристаллических решеток полупроводников, составляющих гетеропереход, должны быть близки, что ограничивает выбор материалов. В настоящее время наиболее исследованными являются пары: германий-арсенид галлия, арсенид галлия-мышьяковидный индий, германий-кремний. Различают n-p- и p-n гетеропереходы (на первое место ставится буква, обозначающая тип электропроводности полупроводника с более узкой запрещенной зоной). На основе гетеропереходов возможно также создание структур n-n и p-p.

Рисунок 1.15. Упрощенная энергетическая диаграмма n-p перехода в равновесном состоянии.
На рисунке 1.15 приведена упрощенная энергетическая диаграмма p-n перехода между арсенидом галлия р-типа (D Wp = 1,5 эВ) и германием n-типа (D Wn = 0,72 эВ) в состоянии равновесия (U = 0). При контакте полупроводников происходит перераспределение носителей зарядов, приводящее к выравниванию уровней Ферми p- и n-областей и возникновению энергетического барьера для электронов n-области qUкn и. для дырок p-области qUкp, причем Uкn > Uкn.
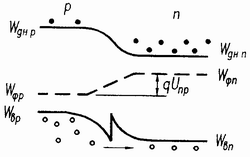
Рисунок 1.16. Упрощенная энергетическая диаграмма n-p гетероперехода, включенного в прямом состоянии.
В состоянии равновесия ток через p-n переход равен нулю. Поскольку потенциальные барьеры для дырок и электронов различны, при приложении к гетеропереходу прямого напряжения смещения он обеспечит эффективную инжекцию дырок из полупроводника с большей шириной запрещенной зоны (рис. 1.16), Эта особенность инжекции в гетеропереходе (явление сверхинжекции) делает его эффективным инжектором.
1.4.2. Контакт между полупроводниками одного типа электропроводности
Контакт полупроводников с одним типом электропроводности, но с разной концентрацией примесей обозначают р+—р или п+-п (знаком "плюс" отмечается полупроводник с большей концентрацией примесей). В таких контактах носители из области с большей концентрацией примеси переходят в область с меньшей концентрацией. При этом в области с повышенной концентрацией нарушается компенсация зарядов ионизированных атомов примеси, а в другой области создается избыток основных носителей зарядов. Образование этих зарядов приводит к появлению на переходе диффузионного электрического поля и контактной разности потенциалов, определяемой следующими соотношениями: для p+-р перехода
![]() ;
;
для n+-n перехода
![]() .
.
В этих переходах не образуется слой с малой концентрацией носителей зарядов, и их сопротивление определяется в основном сопротивлением низкоомной области. Поэтому при прохождении тока непосредственно на контакте падает небольшое напряжение и выпрямительные свойства этих переходов не проявляются. В p+-p и n+-n- переходах отсутствует инжекция неосновных носителей из низкоомной области в высокоомную. Если, например, к переходу n+-n подключен источник тока плюсом к n-области, а минусом к n+-области, то из n+-области в n-область будут переходить электроны, являющиеся в ней основными носителями зарядов. При изменении полярности внешнего напряжения из n+-области в n-область должны инжектироваться дырки, однако их концентрация мала, и этого явления не происходит. Переходы типа p+-p и n+-n возникают при изготовлении омических контактов к полупроводникам.
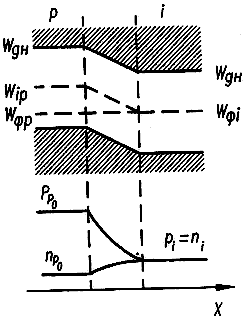
Рисунок 1.17. Энергетическая диаграмма p-i перехода.
Промежуточное положение между p+-p- или n+-n- и p-n переходом занимают p-i и n-i переходы. Такие переходы образуются между двумя пластинами, одна из которых имеет электронную или дырочную электропроводность, а другая - собственную.
На рис 1.17 показаны энергетическая диаграмма и изменение концентраций на границе двух полупроводников с p- и i-областями. Вследствие разности концентраций носителей зарядов в p- и i-областях происходит инжекция дырок из p-области в i-область и электронов из i-области в p-область. Вследствие малой величины инжекционной составляющей электронного тока потенциальный барьер на границе перехода создается неподвижными отрицательными ионами акцепторов р-области и избыточными дырками i-области, диффундирующими в нее из p-области. Поскольку ![]() >>
>> ![]() , глубина распространения запирающего слоя в i-области значительно больше, чем в р-области.
, глубина распространения запирающего слоя в i-области значительно больше, чем в р-области.
1.4.3. Контакт металла с полупроводником
Свойства контакта металла с полупроводником зависят от работы выхода электронов из металла (W0м) и из полупроводника (W0n или W0p). Электроны переходят из материала с меньшей работой выхода в материал с большей работой выхода. При контакте металла с электронным полупроводником при выполнении условия W0n < W0p электроны переходят из полупроводника в металл. Если осуществлен контакт металла с дырочным полупроводником и выполняется условие W0м < W0p, будет происходить переход электронов в полупроводник. И в том, и в другом случае произойдет обеднение свободными носителями заряда приконтактной области полупроводника.
Обедненный слой обладает повышенным сопротивлением, которое может изменяться под воздействием внешнего напряжения. Следовательно, такой контакт имеет нелинейную характеристику и является выпрямляющим. Перенос зарядов в этих контактах осуществляется основными носителями, и в них отсутствуют явления инжекции, накопления и рассасывания зарядов. Таким образом, выпрямляющие контакты металл-полупроводник малоинерционны и служат основой создания диодов с барьером Шоттки, обладающих высоким быстродействием и малым временем переключения.
Если при контакте металла с полупроводником выполняется условие W0м < W0м или W0м > W0p, то приконтактный слой полупроводника обогащается основными носителями заряда и его сопротивление становится низким при любой полярности внешнего напряжения. Такой контакт имеет практически линейную характеристику и является невыпрямляющим.
1.4.4. Омические контакты
Омическими называют контакты, сопротивление которых не зависит от величины и направления тока. Другими словами, это контакты, обладающие практически линейной вольт-амперной характеристикой. Омические контакты обеспечивают соединение полупроводника с металлическими токопроводящими элементами полупроводниковых приборов. Кроме линейности вольт-амперной характеристики, эти контакты должны иметь малое сопротивление и обеспечивать отсутствие инжекции носителей из металлов в полупроводник. Эти условия выполняются путем введения между полупроводником рабочей области кристалла и металлом полупроводника с повышенной концентрацией примеси (рис. 1.18). Контакт между полупроводниками с одинаковым типом электропроводности является невыпрямляющим и низкоомным. Металл выбирают так, чтобы обеспечить малую контактную разность потенциалов. Одним из способов получения омических контактов является введение в металл примеси, которой легирован полупроводник. В этом случае при сплавлении металла с полупроводником в контактной области образуется тонкий слой вырожденного полупроводника, что соответствует структуре, изображенной на рис. 1.18.
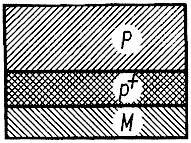
Рисунок 1.18. Структура омического контакта.
1.4.5. Явления на поверхности полупроводника
В результате взаимодействия полупроводника и окружающей среды на поверхности кристалла образуются различные соединения, отличающиеся по своим свойствам от основного материала. Кроме того, обработка кристалла приводит к дефектам кристаллической решетки на поверхности полупроводника. По этим причинам возникают поверхностные состояния, повышающие вероятность появления свободных электронов или незаполненных ковалентных связей. Энергетические уровни поверхностных состояний могут располагаться в запрещенной энергетической зоне и соответствовать донорным и акцепторным примесям.
Поверхностные состояния меняют концентрацию носителей заряда, и в приповерхностном слое полупроводника возникает объемный заряд, приводящий к изменению уровня Ферми. Поскольку в состоянии равновесия уровень Ферми во всем кристалле полупроводника одинаков, поверхностные состояния вызывают искривление энергетических уровней в приповерхностном слое полупроводника.
В зависимости от типа полупроводника и характера поверхностных состояний может происходить обеднение или обогащение поверхности кристалла носителями заряда.
Обеднение возникает в том случае, если поверхностный заряд совпадает по знаку с основными носителями заряда. На рис. 1.19 показано образование обедненного слоя на поверхности полупроводника n-типа при такой плотности поверхностных состояний, что уровни Win и Wфn не пересекаются. Повышение плотности пространственного заряда может привести к пересечению уровня Ферми с уровнем середины запрещенной зоны (рис. 1.20), что соответствует изменению типа электропроводности у поверхности полупроводника. Это явление называют инверсией типа электропроводности, а слой, в котором. оно наблюдается, - инверсным слоем.
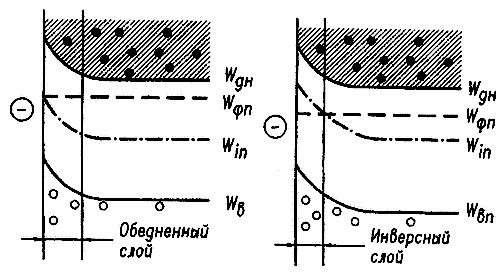
|
Рис. 1.19. Образование обедненного слоя на поверхности полупроводника n-типа. |
Рис. 1.20. Изменение типа электропроводимости на поверхности полупроводника n-типа. |
Если знаки поверхностного заряда и основных носителей противоположны, происходит обогащение приповерхностной области основными носителями зарядов. Такую область называют обогащенным слоем (рис. 1.21).
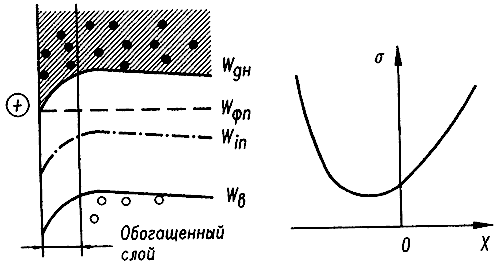
| Рисунок 1.21 Образование обогащенного слоя на поверхности полупроводника n-типа. |
Рисунок 1.22 График изменения типа электропроводности на поверхности полупроводника. |
Электропроводность приповерхностного слоя полупроводника может изменяться под действием электрического поля, возникающего за счет напряжения, прикладываемого к металлу и полупроводнику, разделенным диэлектриком. Если предположить, что до включения напряжения поверхностные состояния на границе полупроводника и диэлектрика отсутствуют, то электропроводности приповерхностного слоя и объема полупроводника будут одинаковыми.
При включении напряжения между металлом и полупроводником возникает электрическое поле, и на поверхности металла и в приповерхностном слое полупроводника, как на пластинах конденсатора, накапливаются заряды. Например, если полупроводник электронный и к нему прикладывается отрицательное напряжение, то под действием электрического поля у поверхности увеличиваются концентрация электронов и электропроводность приповерхностного слоя полупроводника (см. рис. 1.21). При изменении полярности напряжения концентрация электронов в приповерхностном слое уменьшается, а дырок - увеличивается. В связи с этим электропроводность приконтактной области уменьшается, стремясь к собственной. Увеличение напряжения приводит к тому, что концентрация дырок становится выше концентрации электронов и происходит изменение (инверсия) типа электропроводности слоя. При этом электропроводность приповерхностного слоя увеличивается. Зависимость электропроводности приповерхностного слоя полупроводника n-типа от напряжения показана на рис. 1.22. Это явление принято называть эффектом поля.

