3.1. Принцип действия биполярного транзистора. Режимы работы
3.1.2. Физические процессы в бездрейфовом биполярном транзисторе
3.2. Статические характеристики биполярных транзисторов
3.3. Дифференциальные параметры биполярного транзистора в статическом режиме
3.4. Линейная (малосигнальная) модель биполярного транзистора
3.5. Частотные свойства биполярного транзистора
3.6. Способы улучшения частотных свойств биполярных транзисторов
3.7. Работа транзистора в усилительном режиме
3.8. Особенности работы транзистора в импульсном режиме
3.8.1. Работа транзистора в режиме усиления импульсов малой амплитуды
3.1. Принцип действия биполярного транзистора. Режимы работы
3.1.1. Общие сведения
Биполярным транзистором (БТ) называется трехэлектродный полупроводниковый прибор с двумя взаимодействующими p-n переходами, предназначенный для усиления электрических колебаний по току, напряжению или мощности. Слово “биполярный” означает, что физические процессы в БТ определяются движением носителей заряда обоих знаков (электронов и дырок). Взаимодействие переходов обеспечивается тем, что они располагаются достаточно близко - на расстоянии, меньшем диффузионной длины. Два p-n-перехода образуются в результате чередования областей с разным типом электропроводности. В зависимости от порядка чередования различают БТ типа n-p-n (или со структурой n-p-n) и типа p-n-p (или со структурой p-n-p), условные изображения которых показаны на рисунке 3.1.
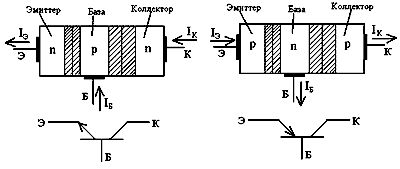
|
а) |
б) |
|
Рисунок 3.1. |
|
Структура реального транзистора типа n-p-n изображена на рисунке 3.2. В этой структуре существуют два перехода с неодинаковой площадью: площадь левого перехода n1+-p меньше, чем у перехода n2-p. Кроме того, у большинства БТ одна из крайних областей (n1 с меньшей площадью) сечения легирована гораздо сильнее, чем другая крайняя область (n2).
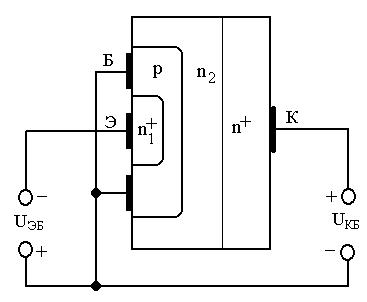
Рисунок 3.2
Сильнолегированная область обозначена верхним индексом “+” (n+). Поэтому БТ является асимметричным прибором. Асимметрия отражается и в названиях крайних областей: сильнолегированная область с меньшей площадью (n1+) называется эмиттером, а область n2 - коллектором. Соответственно переход n1+-р называют эмиттерным, а n2-pколлекторным.Средняя область (p) называется базовой (или базой). Правая область n+ служит для снижения сопротивления коллектора. Контакты с областями БТ обозначены на рисунках 3.1 и 3.2 буквами: Э - эмиттер; Б - база; К- коллектор.
Основные свойства БТ определяются процессами в базовой области, которая обеспечивает взаимодействие эмиттерного и коллекторного переходов. Поэтому ширина базовой области должна быть малой (обычно меньше 1 мкм). Если распределение примеси в базе от эмиттера к коллектору однородное (равномерное), то в ней отсутствует электрическое поле и носители совершают в базе только диффузионное движение. В случае неравномерного распределения примеси (неоднородная база) в базе существует “внутреннее” электрическое поле, вызывающее появление дрейфового движения носителей: результирующее движение определяется как диффузией, так и дрейфом. БТ с однородной базой называют бездрейфовыми, а с неоднородной базой - дрейфовыми.
Биполярный транзистор, являющийся трехполюсным прибором, можно использовать в трех схемах включения: с общей базой (ОБ) (рисунок 3.3,а), общим эмиттером (ОЭ) (рисунок 3.3,б), и общим коллектором (ОК) (рисунок 3.3,в). Стрелки на условных изображениях БТ указывают (как и на рисунке 3.1) направление прямого тока эмиттерного перехода. В обозначениях напряжений вторая буква индекса обозначает общий электрод для двух источников питания.
В общем случае возможно четыре варианта полярностей напряжения переходов, определяющих четыре режима работы транзистора. Они получили названия: нормальный активный режим, инверсный активный режим, режим насыщения (или режим двухсторонней инжекции) и режим отсечки.

|
а) |
б) |
в) |
|
Рисунок 3.3. |
||
В нормальном активном режиме (НАР) на эмиттерном переходе действует прямое напряжение (напряжение эмиттер - база UЭБ), а на коллекторном переходе - обратное (напряжение коллектор - база UКБ). Этому режиму соответствуют полярности источников питания на рисунке 3.4 и направления токов для p-n-p транзистора. В случае n-p-n транзистора полярности напряжения и направления токов изменяются на противоположные.

Рисунок 3.4.
Этот режим работы (НАР) является основным и определяет назначение и название элементов транзистора. Эмиттерный переход осуществляет инжекцию носителей в узкую базовую область, которая обеспечивает практически без потерь перемещение инжектированных носителей до коллекторного перехода. Коллекторный переход не создает потенциального барьера для подошедших носителей, ставших неосновными носителями заряда в базовой области, а, наоборот, ускоряет их и поэтому переводит эти носители в коллекторную область. “Собирательная” способность этого перехода и обусловила название “коллектор”. Коллектор и эмиттер могут поменяться ролями, если на коллекторный переход подать прямое напряжение UКБ, а на эмиттерный - обратное UЭБ. Такой режим работы называется инверсным активным режимом (ИАР). В этом случае транзистор “работает” в обратном направлении: из коллектора идет инжекция дырок, которые проходят через базу и собираются эмиттерным переходом, но при этом его параметры отличаются от первоначальных.
Режим работы, когда напряжения на эмиттерном и коллекторном переходах являются прямыми одновременно, называют режимом двухсторонней инжекции (РДИ) или менее удачно режимом насыщения (РН). В этом случае и эмиттер, и коллектор инжектируют носители заряда в базу навстречу друг другу и одновременно каждый из переходов собирает носители, приходящие к нему от другого перехода.
Наконец, режим, когда на обоих переходах одновременно действуют обратные напряжения, называют режимом отсечки (РО), так как в этом случае через переходы протекают малые обратные токи.
Следует подчеркнуть, что классификация режимов производится по комбинации напряжений переходов, В схеме включения с общей базой (ОБ) они равны напряжениям источников питания UЭБ и UКБ. В схеме включения с общим эмиттером (ОЭ) напряжение на эмиттерном переходе определяется напряжением первого источника (UЭБ = -UБЭ), а напряжение коллекторного перехода зависит от напряжений обоих источников и по общему правилу определения разности потенциалов UКБ = UКЭ + UЭБ. Так как UЭБ = -UБЭ, тo UКБ = UКЭ - UБЭ; при этом напряжение источников питания надо брать со своим знаком: положительным, если к электроду присоединен положительный полюс источника, и отрицательным - в другом случае. В схеме включения с общим коллектором (ОК) напряжение на коллекторном переходе определяется одним источником: UКБ = -UБК. Напряжение на эмиттерном переходе зависит от обоих источников: UЭБ = UЭК + UКБ = UЭК - UБК, при этом правило знаков прежнее.
3.1.2. Физические процессы в бездрейфовом биполярном транзисторе
Основные физические процессы в идеализированном БТ удобно рассматривать на примере схемы с общей базой (рисунок 3.4), так как напряжения на переходах совпадают с напряжениями источников питания. Выбор p-n-p транзистора связан с тем, что направление движения инжектируемых из эмиттера носителей (дырок) совпадает с направлением тока.
В нормальном активном режиме (НАР) на эмиттерном переходе действует прямое напряжение UЭБ. Поэтому прямой ток перехода
![]() , (3.1)
, (3.1)
где Iэ р, Iэ n - инжекционные токи дырок (из эмиттера в базу) и электронов (из базы в эмиттер), а Iэ рек - составляющая тока, вызванная рекомбинацией в переходе тех дырок и электронов, энергия которых недостаточна для преодоления потенциального барьера. Относительный вклад этой составляющей в ток перехода Iэ в (3.1) тем заметнее, чем меньше инжекционные составляющие Iэр и Iэn, определяющие прямой ток в случае идеализированного р-n перехода. Если вклад Iэ рек незначителен, то вместо (3.1) можно записать
![]() . (3.2)
. (3.2)
Полезным в сумме токов выражения (3.1) является только ток Iэ р, так как он будет участвовать в создании тока коллекторного перехода. “Вредные” составляющие тока эмиттера Iэ n и Iэ рек протекают через вывод базы и являются составляющими тока базы, а не коллектора. Поэтому вредные компоненты Iэ n, Iэ рек должны быть уменьшены.
Эффективность работы эмиттерного перехода учитывается коэффициентом инжекции эмиттера
![]() , (3.3)
, (3.3)
который показывает, какую долю в полном токе эмиттера составляет полезный компонент. В случае пренебрежения током Iэ рек
![]() . (3.4)
. (3.4)
Коэффициент инжекции g Э "тем выше (ближе к единице), чем меньше отношение Iэ n/ Iэ р. Величина Iэ n/ Iэ р << 1, если концентрация акцепторов в эмиттерной области p-n-p транзистора NАЭ на несколько порядков выше концентрации доноров NДБ в базе (NАЭ >> NДБ). Это условие обычно и выполняется в транзисторах.
Какова же судьба дырок, инжектированных в базу из эмиттера, определяющих полезный ток IЭр? Очевидно, что инжектированные дырки повышают концентрацию дырок в базе около границы с эмиттерным переходом, т.е. вызывают появление градиента концентрации дырок - неосновных носителей базы. Этот градиент обусловливает диффузионное движение дырок через базу к коллекторному переходу. Очевидно, что это движение должно сопровождаться рекомбинацией части потока дырок. Потерю дырок в базе можно учесть введением тока рекомбинации дырок IБ рек, так что ток подходящих к коллекторному переходу дырок
![]() . (3.5)
. (3.5)
Относительные потери на рекомбинацию в базе учитывают коэффициентом переноса:
![]() . (3.6)
. (3.6)
Коэффициент переноса показывает, какая часть потока дырок, инжектированных из эмиттера в базу, подходит к коллекторному переходу. Значение c Б тем ближе к единице, чем меньшее число инжектированных дырок рекомбинирует с электронами - основными носителями базовой области. Ток IБ рек одновременно характеризует одинаковую потерю количества дырок и электронов. Так как убыль электронов в базе вследствие рекомбинации в конце концов покрывается за счет прихода электронов через вывод базы из внешней цепи, то ток IБ рек следует рассматривать как составляющую тока базы наряду с инжекционной составляющей IЭ n.
Чтобы уменьшить потери на рекомбинацию, т.е. увеличить c Б, необходимо уменьшить концентрацию электронов в базе и ширину базовой области. Первое достигается снижением концентрации доноров Nд Б. Это совпадает с требованием NАЭ/NДБ, необходимым для увеличения коэффициента инжекции. Потери на рекомбинацию будут тем меньше, чем меньше отношение ширины базы WБ и диффузионной длины дырок в базовой области Lp Б. Доказано, что имеется приближенное соотношение
![]() . (3.7)
. (3.7)
Например, при WБ/Lp Б = 0,1 c Б = 0,995, что очень мало отличается от предельного значения, равного единице.
Если при обратном напряжении в коллекторном переходе нет лавинного размножения проходящих через него носителей, то ток за коллекторным переходом с учетом (3.5)
![]() (3.8)
(3.8)
С учетом (3.6) и (3.3) получим
![]() , (3.9)
, (3.9)
где
![]() . (3.10)
. (3.10)
Это отношение дырочной составляющей коллекторного тока к полному току эмиттера называет статическим коэффициентом передачи тока эмиттера.
Ток коллектора имеет еще составляющую IКБО, которая протекает в цепи коллектор - база при IЭ = 0 (холостой ход, “обрыв” цепи эмиттера), и не зависит от тока эмиттера. Это обратный ток перехода, создаваемый неосновными носителями областей базы и коллектора, как в обычном p-n переходе (диоде).
Таким образом, полный ток коллектора с учетом (3.8) и (3.10)
![]() . (3.11)
. (3.11)
Из (3.11) получим обычно используемое выражение для статического коэффициента передачи тока:
![]() , (3.12)
, (3.12)
числитель которого (IК - IКБО) представляет собой управляемую (зависимую от тока эмиттера) часть тока коллектора, IКр. Обычно рабочие токи коллектора IК значительно IКБО, поэтому
![]() . (3.13)
. (3.13)
С помощью рисунка 3.4 можно представить ток базы через компоненты:
![]() . (3.14)
. (3.14)
По первому закону Кирхгофа для общей точки
![]() . (3.15)
. (3.15)
Как следует из предыдущего рассмотрения, IК и IБ принципиально меньше тока IЭ; при этом наименьшим является ток базы
![]() . (3.16)
. (3.16)
Используя (3.16) и (3.11), получаем связь тока базы с током эмиттера
![]() . (3.17)
. (3.17)
Если в цепи эмиттера нет тока (IЭ = 0, холостой ход), то IБ = -IКБО, т. е. ток базы отрицателен и по величине равен обратному току коллекторного перехода. При значении I*Э = IКБО /(1-a ) ток IБ = 0, а при дальнейшем увеличении IЭ (IЭ>I*Э) ток базы оказывается положительным.
Подобно (3.11) можно установить связь IК с IБ. Используя (3.11) и (3.15), получаем
![]() , (3.18)
, (3.18)
где
![]() (3.19)
(3.19)
- статический коэффициент передачи тока базы. Так как значение a обычно близко к единице, то b может быть очень большим (b >>1). Например, при a = 0,99 b = 99. Из (3.18) можно получить соотношение
![]() . (3.20)
. (3.20)
Очевидно, что коэффициент b есть отношение управляемой (изменяемой) части коллекторного тока (IК - IКБО) к управляемой части базового тока (IБ + IКБО). Действительно, используя (3.14), получаем
![]() .
.
Все составляющие последнего выражения зависят от IЭ и обращаются в нуль при IЭ = 0. Введя обозначение
![]() , (3.21)
, (3.21)
можно вместо (3.18) записать
![]() . (3.22)
. (3.22)
Отсюда очевиден смысл введенного обозначения IКЭО это значение тока коллектора при нулевом токе базы (IБ = 0) или при “обрыве” базы. При IБ = 0
IК = IЭ, поэтому ток IКЭО проходит через все области транзистора и является “сквозным” током, что и отражается индексами “К” и “Э” (индекс “О” указывает на условие IБ = 0).
3.2. Статические характеристики биполярных транзисторов
Обычно анализируют входные и выходные характеристики БТ в схемах с общей базой и общим эмиттером. Для определенности и преемственности изложения будем рассматривать p-n-p-транзистор.
3.2.1. Схема с общей базой
Семейство входных характеристик схемы с ОБ представляет собой зависимость IЭ = f(UЭБ) при фиксированных значениях параметра UКБ - напряжения на коллекторном переходе (рисунок 3.5,а).
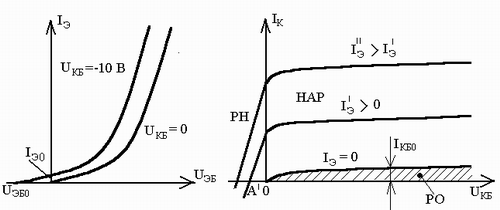
|
а) |
б) |
|
Рисунок 3.5 |
|
При UКБ = 0 характеристика подобна ВАХ p-n-перехода. С ростом обратного напряжения UКБ (UКБ < 0 для p-n-p-транзистора) вследствие уменьшения ширины базовой области (эффект Эрли) происходит смещение характеристики вверх: IЭ растет при выбранном значении UЭБ. Если поддерживается постоянным ток эмиттера (IЭ = const), т.е. градиент концентрации дырок в базовой области остается прежним, то необходимо понизить напряжение UЭБ, (характеристика сдвигается влево). Следует заметить, что при UКБ < 0 и UЭБ = 0 существует небольшой ток эмиттера IЭ0, который становится равным нулю только при некотором обратном напряжении UЭБ0.
Семейство выходных характеристик схемы с ОБ представляет собой зависимости IК = f(UКБ) при заданных значениях параметра IЭ (рисунок 3.5,б).
Выходная характеристика p-n-p-транзистора при IЭ = 0 и обратном напряжении |UКБ < 0| подобна обратной ветви p-n-перехода (диода). При этом в соответствии с (3.11) IК = IКБО, т. е. характеристика представляет собой обратный ток коллекторного перехода, протекающий в цепи коллектор - база.
При IЭ > 0 основная часть инжектированных в базу носителей (дырок в p-n-p транзисторе) доходит до границы коллекторного перехода и создает коллекторный ток при UКБ = 0 в результате ускоряющего действия контактной разности потенциалов. Ток можно уменьшить до нуля путем подачи на коллекторный переход прямого напряжения определенной величины. Этот случай соответствует режиму насыщения, когда существуют встречные потоки инжектированных дырок из эмиттера в базу и из коллектора в базу. Результирующий ток станет равен нулю, когда оба тока одинаковы по величине (например, точка А' на рисунок 3.5,б). Чем больше заданный ток IЭ, тем большее прямое напряжение UКБ требуется для получения IК = 0.
Область в первом квадранте на рис. 3.5,б, где UКБ < 0 (обратное) и параметр IЭ > 0 (что означает прямое напряжение UЭБ) соответствует нормальному активному режиму (НАР). Значение коллекторного тока в НАР определяется формулой (3.11) IК = a IЭ + IКБО. Выходные характеристики смещаются вверх при увеличении параметра IЭ. В идеализированном транзисторе не учитывается эффект Эрли, поэтому интегральный коэффициент передачи тока a можно считать постоянным, не зависящим от значения |UКБ|. Следовательно, в идеализированном БТ выходные характеристики оказываются горизонтальными (IК = const). Реально же эффект Эрли при росте |UКБ| приводит к уменьшению потерь на рекомбинацию и росту a . Так как значение a близко к единице, то относительное увеличение а очень мало и может быть обнаружено только измерениями. Поэтому отклонение выходных характеристик от горизонтальных линий вверх “на глаз” не заметно (на рисунке 3.5,б не соблюден масштаб).
3.2.2. Схема с общим эмиттером
Семейство входных характеристик схемы с ОЭ представляет собой зависимости IБ = f(UБЭ), причем параметром является напряжение UКЭ (рисунок 3.6,а). Для p-n-p транзистора отрицательное напряжение UБЭ (UБЭ < 0) означает прямое включение эмиттерного перехода, так как UЭБ = -UБЭ > 0. Если при этом UКЭ = 0 (потенциалы коллектора и эмиттера одинаковы), то и коллекторный переход будет включен в прямом направлении: UКБ = UКЭ + UЭБ = UЭБ > 0. Поэтому входная характеристика при UКЭ = 0 будет соответствовать режиму насыщения (РН), а ток базы равным сумме базовых токов из-за одновременной инжекции дырок из эмиттера и коллектора. Этот ток, естественно, увеличивается с ростом прямого напряжения UЭБ, так как оно приводит к усилению инжекции в обоих переходах (UКБ = UЭБ) и соответствующему возрастанию потерь на рекомбинацию, определяющих базовый ток.
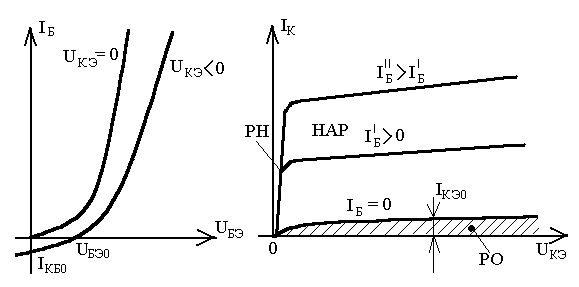
|
а) |
б) |
|
Рисунок 3.6 |
|
Вторая характеристика на рисунке 3.6,а (UКЭ á 0) относится к нормальному активному режиму, для получения которого напряжение UКЭ должно быть в p-n-p транзисторе отрицательным и по модулю превышать напряжение UЭБ. В этом случае (UКБ = UКЭ + UЭБ = UКЭ - UБЭ < 0. Формально ход входной характеристики в НАР можно объяснить с помощью выражения (3.14) или (3.17): IБ =(1 - a )IЭ - IКБО. При малом напряжении UБЭ инжекция носителей практически отсутствует (IЭ = 0) и ток
IБ = -IКБО, т.е. отрицателен. Увеличение прямого напряжения на эмиттерном переходе UЭБ = -UБЭ вызывает рост IЭ и величины (1 - a ) IЭ. Когда (1 - a ) IЭ = IКБО, ток IБ = 0. При дальнейшем роете UБЭ (1 - a ) IЭ > IКБО и IБ меняет направление и становится положительным (IБ > 0) и сильно зависящим от напряжения перехода.
Влияние UКЭ на IБ в НАР можно объяснить тем, что рост |UКЭ| означает рост |UКБ| и, следовательно, уменьшение ширины базовой области (эффект Эрли). Последнее будет сопровождаться снижением потерь на рекомбинацию, т.е. уменьшением тока базы (смещение характеристики незначительно вниз).
Семейство выходных характеристик схемы с ОЭ представляет собой зависимости IК = f(UКЭ) при заданном параметре IБ (рисунок 3.6,б).
Крутые начальные участки характеристик относятся к режиму насыщения, а участки с малым наклоном - к нормальному активному режиму. Переход от первого режима ко второму, как уже отмечалось, происходит при значениях |UКЭ|, превышающих |UБЭ|. На характеристиках в качестве параметра берется не напряжение UБЭ, а входной ток IБ. Поэтому о включении эмиттерного перехода приходится судить по значению тока IБ, который связан с входной характеристикой на рисунке 3.6,а. Для увеличения IБ необходимо увеличивать |UБЭ|, следовательно, и граница между режимом насыщения и нормальным активным режимом должна сдвигаться в сторону больших значений.
Если параметр IБ = 0 (“обрыв” базы), то в соответствии с (3.22) IК = IКЭО = (b + 1 ) IКБО. В схеме с ОЭ можно получить (как и в схеме с ОБ) I = IКБО, если задать отрицательный ток IБ = -IКБО. Выходная характеристика с параметром IБ = -IКБО может быть принята за границу между НАР и режимом отсечки (РО). Однако часто за эту границу условно принимают характеристику с параметром IБ = 0.
Наклон выходных характеристик в нормальном активном режиме в схеме с общим эмиттером во много раз больше, чем в схеме с общей базой (h22Э » b h22Б) Объясняется это различным проявлением эффекта Эрли. В схеме с общим эмиттером увеличение UКЭ, а следовательно и UКБ сопровождается уменьшением тока базы, а он по определению выходной характеристики должен быть неизменным. Для восстановления тока базы приходится регулировкой напряжения UБЭ увеличивать ток эмиттера, а это вызывает прирост тока коллектора D IК, т.е. увеличение выходной проводимости (в схеме с ОБ ток IЭ при снятии выходной характеристики поддерживается неизменным).
3.2.3. Влияние температуры на статические характеристики БТ
Влияние температуры на положение входной характеристики схемы с ОБ при поддержании неизменным ее параметра аналогично ее влиянию на ВАХ полупроводникового диода. В нормальном активном режиме ток эмиттерного перехода можно представить формулой
![]() .
.
С ростом температуры тепловой ток IЭО растет быстрее, чем убывает экспонента из-за увеличения j Т = kT/q. В результате противоположного влияния двух факторов входные характеристики схемы с ОБ смещаются влево при выбранном токе IЭ на величину D U » (1...2) мВ/°С (рисунок 3.7,а).
Начало входной характеристики в схеме с ОЭ определяется тепловым током коллекторного перехода IКБО который сильно зависит от температуры, так что начало характеристики при увеличении температуры опускается (рисунок 3.7, б).
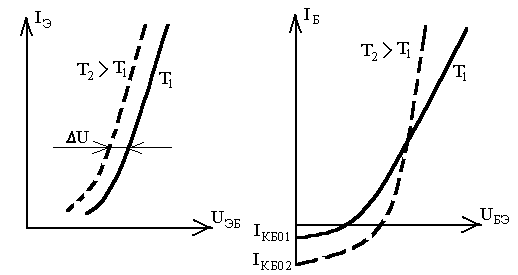
|
а) |
б) |
|
Рисунок 3.7 |
|
Влияние температуры на выходные характеристики схем с ОБ и ОЭ в НАР удобно анализировать по формулам (3.11) и (3.22):
![]() и
и ![]() .
.
Снятие выходных характеристик при различных температурах должно проводиться при поддержании постоянства параметров (IЭ = const в схеме с ОБ и IБ = const в схеме с ОЭ). Поэтому в схеме с ОБ при IЭ = const рост IК будет определяться только увеличением IКБО (рисунок 3.8, а).
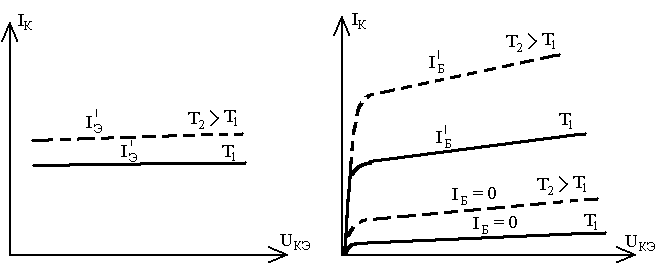
|
а) |
б) |
|
Рисунок 3.8 |
|
Однако обычно IКБО значительно меньше a IЭ, изменение IК составляет доли процента и его можно не учитывать.
В схеме с ОЭ положение иное. Здесь параметром является IБ и его надо поддерживать неизменным при изменении температуры. Будем считать в первом приближении, что коэффициент передачи b не зависит от температуры. Постоянство b IБ означает, что температурная зависимость IК будет определяться слагаемым (b + 1)IКБО. Ток IКБО (как тепловой ток перехода) примерно удваивается при увеличении температуры на 10°С, и при b >> 1 прирост тока (b + 1)IКБО может оказаться сравнимым с исходным значением коллекторного тока и даже превысить его.
На рисунке 3.8,б показано большое смещение выходных характеристик вверх. Сильное влияние температуры на выходные характеристики в схеме с ОЭ может привести к потере работоспособности конкретных устройств, если не принять схемотехнические меры для стабилизации тока или термостатирование.
3.3. Дифференциальные параметры биполярного транзистора в статическом режиме
Статические характеристики и их семейства наглядно связывают постоянные токи электродов с постоянными напряжениями на них. Однако часто возникает задача установить количественные связи между небольшими изменениями (дифференциалами) этих величин от их исходных значений. Эти связи характеризуют коэффициентами пропорциональности -дифференциальными параметрами.
Рассмотрим процедуру введения дифференциальных параметров БТ на примере наиболее распространенных h-параметров, приводимых в справочниках по транзисторам. Для введения этой системы параметров в качестве независимых переменных при описании статического режима берут входной ток IВХ (IЭ или IБ) и выходное напряжение UВЫХ (UKБ или (UКЭ):
U1= f (I1,U2) (3.23)
I2= f (I1,U2)
В этом случае полные дифференциалы
![]() (3.24)
(3.24)
![]()
Частные производные в выражениях (3.24) и являются дифференциальными h-napaметрами, т.е.
dU1=h11 d I1 +h12 dU2 (3.25)
dI2=h21 dI1 + h22 dU2
(h11 -входное сопротивление, h12 -коэффициент обратной передачи, h21 -коэффициент передачи входного тока и h22 -выходная проводимость). Названия и обозначения этих параметров взяты из теории четырехполюсников для переменного тока.
Приращения статических величин в нашем случае имитируют переменные токи и напряжения.
Для схемы с общей базой
dUЭБ=h11Б d IЭ +h12Б dUКБ (3.26)
dIК=h21Б dIЭ + h22Б dUКБ
Эти уравнения устанавливают и способ нахождения по статическим характеристикам, и метод измерения h-параметров. Полагая dUКБ = 0, т.е. UКБ = const, можно найти h11Б и h21Б, а считая dIЭ = 0, т. е. IЭ = const. определить h12Б и h22Б.
Аналогично для схемы с общим эмиттером можно переписать (3.26) в виде
dUБЭ=h11Э d IБ +h12Э dUКЭ (3.27)
dIК=h21Э dIБ + h22Э dUКЭ
Связь h-параметров со статическими характеристиками схем с ОБ и ОЭ и их определение по ним рассмотрены в.
3.4. Линейная (малосигнальная) модель биполярного транзистора
В качестве малосигнальных моделей могут быть использованы эквивалентные схемы с дифференциальными h-, у- и z-параметрами, которые имеют формальный характер и в которых отсутствуют непосредственная связь с физической структурой транзистора. Например, эквивалентная схема для системы Н-параметров приведена на рисунке.
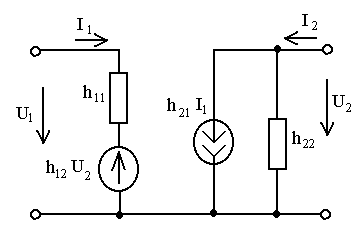
Рисунок 3.9
Широкое распространение нашли эквивалентные схемы с так называемыми физическими параметрами, которые опираются на нелинейную динамическую модель Эберса - Молла, т.е. тесно связаны с физической структурой биполярного транзистора.
Малосигнальную схему БТ легко получить из нелинейной динамической модели заменой эмиттерного и коллекторного диодов их дифференциальными сопротивлениями, устанавливающими связь между малыми приращениями напряжения и тока. Кроме того, в усилительных схемах используется либо нормальный активный, либо инверсный активный режим, а режим насыщения недопустим. Поэтому при переходе к малосигнальной схеме можно ограничиться рассмотрением наиболее распространенного нормального активного режима, так как результаты легко перенести и на инверсный активный режим. В этом случае можно исключить генератор тока и малосигнальную модель БТ для схемы включения с ОБ изобразить, как на рисунке 3.10.
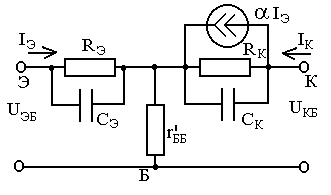
Рисунок 3.10
Поясним смысл элементов модели. Резистор RЭ представляет дифференциальное сопротивление эмиттерного перехода. В первом приближении его можно определить по формуле для идеализированного р-n перехода:
RЭ=dU/dI» j T/IЭ, (3.28)
где IЭ- постоянная составляющая тока эмиттера. Так как при комнатной температуре j т = 0,026 В, то при IЭ = 1 мА RЭ = 26 Ом.
Величина RК называется дифференциальным сопротивлением коллекторного перехода. Оно обусловлено эффектом Эрли и может быть определено по наклону выходной характеристики:
![]() . (3.29)
. (3.29)
Величина RК обратно пропорциональна значению параметра h22Б. Дифференциальное сопротивление коллектора может составлять сотни килоом и мегаомы, тем не менее его следует учитывать.
Реактивные элементы модели (Сэ, Ск) оказались теперь присоединенными параллельно резисторам RЭ и RК. Сопротивление базы r½ ББ, которое может превышать сотни ом, всегда остается в модели.
r½ ББ=h12/h22 . (3.30)
Приведенная эквивалентная малосигнальная модель БТ формально относится к схеме включения с ОБ. Однако она применима и для схемы с ОЭ. Для этого достаточно поменять местами плечи этой схемы, называемой Т-образной схемой с физическими параметрами. Электрод “Б” следует изобразить входным, а “Э” - общим, как показано на рисунке 3.11.
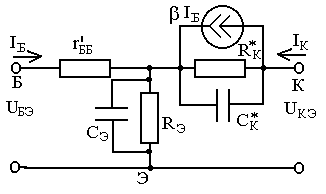
Рисунок 3.11
Значения всех элементов остаются прежними. Однако при таком изображении появляется некоторое неудобство, связанное с тем, что зависимый генератор тока в коллекторной цепи выражается не через входной ток (ток базы). Этот недостаток легко устранить преобразованием схемы к виду, изображенному на рисунке 3.11. Чтобы обе схемы были равноценными четырехполюсниками, они должны иметь одинаковые параметры в режимах холостого хода и короткого замыкания. Это требует перехода от тока H21БIЭ к току Н21ЭIБ и замены RК и CК на RК* и CК* соответственно. Связи этих величин определяются формулами
RК*=Н21БRК/ Н21Э=RК /( Н21Э+1) , ( 3.31 )
СК*= СК( Н21Э+1) . ( 3.32 )
Легко убедиться, что RК* характеризует наклон выходной характеристики (эффект Эрли) в схеме с ОЭ и связан с выходной проводимостью в этой схеме соотношением (5.43). Во сколько раз уменьшается RК* по сравнению с RК, во столько же раз возрастает емкость СK* по сравнению с СK, т.е. RKCK =RK*CK*.
3.5. Частотные свойства биполярного транзистора
Частотные свойства определяют диапазон частот синусоидального сигнала, в пределах которого прибор может выполнять характерную для него функцию преобразования сигнала. Принято частотные свойства приборов характеризовать зависимостью величин его параметров от частоты. Для биполярных транзисторов используется зависимость от частоты коэффициента передачи входного тока в схемах ОБ и ОЭ Н21Б и Н21Э. Обычно рассматривается нормальный активный режим при малых амплитудах сигнала в схемах включения с ОБ и ОЭ.
В динамическом режиме вместо приращения токов необходимо брать комплексные амплитуды, поэтому и коэффициенты передачи заменяются комплексными (частотно зависимыми) величинами: Н21Б и Н21Э.
Величины Н21Б и Н21Э могут быть найдены двумя способами:
• решением дифференциальных уравнений физических процессов и определением из них токов;
• анализом Т-образной эквивалентной схемы по законам теории электрических цепей.
Во втором случае Н21Б и Н21Э будут выражены через величины электрических элементов схемы. Мы проведем анализ частотных свойств коэффициентов передачи, используя Т-образную линейную модель (эквивалентную схему) n-р-n транзистора (рисунки 3.10 и 3.11).
На частотные свойства БТ влияют СЭ, СК и r½ ББ, а также время пролета носителей через базу t Б.
Нет надобности рассматривать влияние на частотные свойства транзистора каждого элемента в отдельности. Совместно все эти факторы влияют на коэффициент передачи тока эмиттера Н21Б, который становится комплексным, следующим образом:
 , (3.33 )
, (3.33 )
где Н21Б0- коэффициент передачи тока эмиттера на низкой частоте, f - текущая частота, fН21Б- предельная частота. Модуль коэффициента передачи тока эмиттера равен
 ( 3.34 ).
( 3.34 ).
Не трудно заметить, что модуль коэффициента передачи ½ Н21Б½ на предельной частоте fН21Б снижается в ![]() раз. Сдвиг по фазе между входным и выходным токами определяется формулой
раз. Сдвиг по фазе между входным и выходным токами определяется формулой
![]() . ( 3.35 )
. ( 3.35 )
Для схемы с ОЭ известно соотношение
![]() ( 3.36 ).
( 3.36 ).
Подставляя (3.33) в (3.36) получим
 (3.37),
(3.37),
где ![]() . Модуль коэффициента передачи тока базы будет равен
. Модуль коэффициента передачи тока базы будет равен
 (3.38).
(3.38).
Как видно, частотные свойства БТ в схеме ОЭ значительно уступают транзистору, включенному по схеме с ОБ.
Граничная частота fГР - это такая частота, на которой модуль коэффициента передачи ½ Н21Э½ =1. В итоге получим, что fГР» fН21Э× Н21Э0.
Транзистор можно использовать в качестве генератора или усилителя только в том случае, если его коэффициент усиления по мощности КP> 1. Поэтому обобщающим частотным параметром является максимальная частота генерирования или максимальная частота усиления по мощности, на которой коэффициент усиления по мощности равен единице. Связь этой частоты с высокочастотными параметрами определяется выражением
![]() , ( 3.39 ).
, ( 3.39 ).
где fН21Б - предельная частота в мегагерцах; r1ББ - объемное сопротивление в омах; CК - емкость коллекторного перехода в пикофарадах; fМАКС - в мегагерцах.
3.6. Способы улучшения частотных свойств биполярных транзисторов
Рассмотренное выше позволяет сделать следующие выводы. Для улучшения частотных свойств (повышение предельной частоты) рекомендуется следующее.
1. Уменьшать время пролета инжектированных носителей в базовой области, т.е.
а) уменьшать ширину базовой области WБ; б) создавать n-р-n транзисторы, так как подвижность электронов выше, чем у дырок, примерно в 2 раза; в) использовать германиевые БТ, так как в германии подвижность носителей выше. Еще большие возможности открывает использование арсенида галлия.
2. Создавать ускоряющее поле в базовой области для инжектированных из эмиттера носителей. Последнее возникает при неравномерном распределении примесей в базе по направлению от эмиттера к коллектору (рис. 5.31,б). Концентрацию около эмиттера делают примерно в 100 раз больше, чем около коллектора.
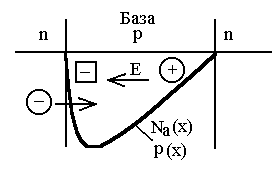
Рисунок 3.12
Появление поля объясняется просто. Так как концентрация основных носителей в любой точке базы (дырок n-р-n транзистора) приблизительно равна концентрации примесей в этой точке, то распределение примесей Na(х) одновременно будет и распределением дырок p(х). Под влиянием градиента концентрации дырок будет происходить их диффузионное движение к коллектору, приводящее к нарушению условия электрической нейтральности: около эмиттера будет избыток отрицательного заряда ионов акцепторов, а около коллектора - избыток положительного заряда дырок, которые приходят к коллекторному переходу, но не проходят через него.
Нарушение электрической нейтральности приводит к появлению внутреннего электрического поля в базовой области (минус у эмиттера, плюс у коллектора). Появляющееся поле, в свою очередь, вызовет встречное дрейфовое движение дырок. Нарастание поля и дрейфового потока будет происходить до того момента, когда дрейфовый и диффузионный токи дырок уравняются. Легко видеть, что установившееся (равновесное) значение поля будет ускоряющим для электронов, которые входят в рабочем режиме из эмиттера в базу и будут уменьшать их время пролета, т.е. повышать предельную частоту БТ.
Биполярные транзисторы с неравномерным распределением примесей в базе, приводящим к появлению ускоряющего поля, называются дрейфовыми, а обычные - бездрейфовыми. Практически все современные высокочастотные и сверхвысокочастотные БТ являются дрейфовыми.
Уменьшение времени пролета в базовой области n-р-n транзистора при экспоненциальном законе убывания концентрации акцепторов от Nа(0) до Nа(WБ) учитывается коэффициентом неоднородности базы:
h =0,5ln[ NА(0)/NА(WБ)]
Поэтому можно написать
![]()
Для бездрейфовых транзисторовh =0 , а типичные значения для дрейфовых транзисторов ![]() .
.
3. Уменьшать барьерные емкости эмиттерного и коллекторного переходов путем уменьшения сечения областей транзистора и увеличения ширины переходов (выбором концентрации примесей и рабочего напряжения).
4. Уменьшать омическое сопротивление областей базы r½ ББ.
5. Уменьшать время пролета носителей в области коллекторного перехода.
Следует отметить, что ряд требований несовместимы и необходимо при создании транзисторов применять компромиссные решения.
3.7. Работа транзистора в усилительном режиме
При работе транзистора в различных радиотехнических устройствах в его входную цепь поступают сигналы, например переменные напряжения. Под действием входного переменного напряжения изменяются входной и выходной токи транзистора.
Для выделения полезного сигнала в выходную цепь транзистора включают элементы нагрузки. В простейшем случае нагрузкой может служить резистор Rк. На резисторе нагрузки за счет прохождения выходного тока выделяется, кроме постоянного, переменное напряжение. Амплитуда этого напряжения зависит от амплитуды переменной составляющей выходного тока и сопротивления резистора Rк и может быть больше входного напряжения. Процесс усиления сигнала удобно рассмотреть на примере простейших усилителей.
Простейшая схема усилителя на транзисторе, включенном по схеме с ОЭ, показана на рисунке 3.13.
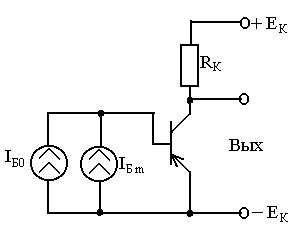
Рисунок 3.13
Коллекторная цепь состоит из резистора Rк и источника Ек, а цепь базы - из источников тока IБ0 и IБm Источник IБ0 обеспечивает положение исходной рабочей точке на участке характеристик с наименьшей нелинейностью. Источник IБm- источник сигнала. В качестве выходного используется переменное напряжение, выделяемое на резисторе нагрузки Rк (на коллекторе транзистора).
Работа такого усилителя поясняется временными диаграммами токов и напряжений, изображенными на рис. 3..
При IБm =0 токи базы и коллектора будут определяться токами в рабочей точке (IБ 0, IК 0)и напряжением на коллекторе UК0= ЕК-IК0 × Rк
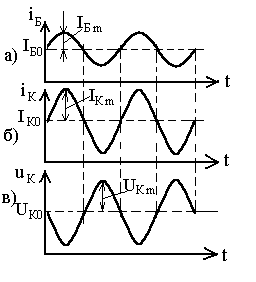
Рисунок 3.14
Во время положительного полупериода входного тока (рис. 3.14.,а) прямое напряжение эмиттерного перехода увеличивается, что вызывает рост тока коллектора (рис. 3.14,б) и уменьшение напряжения UКЭ за счет увеличения падения напряжения на сопротивлении коллектора (рисунок 3.14,в). Если работа происходит на линейных участках характеристик транзистора, то формы переменных составляющих токов базы и коллектора совпадают с формой входного напряжения, а переменное напряжение на коллекторе, обусловленной переменной составляющей коллекторного тока, оказывается сдвинутым относительно входного напряжения на 1800. При соответствующем выборе сопротивления нагрузки Rк амплитуда переменного напряжения на выходе такого усилителя Umвых=IКmRк может значительно превышать амплитуду входного напряжения.
3.8. Особенности работы транзистора в импульсном режиме
3.8.1. Работа транзистора в режиме усиления импульсов малой амплитуды
Если транзистор работает в режиме усиления импульсных сигналов малой амплитуды, то такой режим работы в принципе не отличается от линейного усиления малых синусоидальных сигналов. Импульс в этом случае может быть представлен в виде суммы ряда гармонических составляющих. Зная частотные свойства транзистора, можно определить искажения формы импульсов, возникающие при усилении.
Схема импульсного усилителя не отличается от схемы усилителя гармонических сигналов (рисунок 3.13).
3.8.2. Работа транзистора в режиме переключения
Биполярный транзистор широко используется в электронных устройствах в качестве ключа - функцией которого является замыкание и размыкание электрической цепи. Имея малое сопротивление во включенном состоянии и большое - в выключенном, биполярный транзистор достаточно полно удовлетворяет требованиям, предъявляемым к ключевым элементам.
Схема транзисторного ключа показана на рисунке 3.15. Во входной цепи действуют источник смещения ЕБЭ, создающий обратное напряжение на эмиттерном переходе, источник управляющих импульсов прямого напряжения UВХ и ограничительный резистор RБ. Обычно RБ> > Н11Э. В выходной цепи включены сопротивление нагрузки RК и источник питания ЕКЭ.
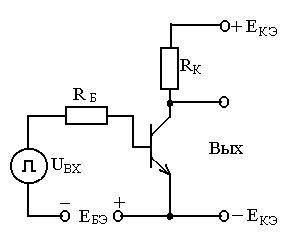
Рисунок 3.15
Когда нет импульса на входе, транзистор находится в режиме отсечки и ток коллектора практически отсутствует IК» IКБ0 (точка А на выходных характеристиках (рисунок 3.16,б). Напряжение на выходе транзистора uКЭ= ЕКЭ-IК× RК » ЕКЭ.
При подаче на вход транзистора импульсов прямого тока iБ=(UВХ- EБЭ)/RБ=IБ НАС, транзистор открывается, рабочая точка перемещается в точку Б (режим насыщения) и напряжение на коллекторе падает до значения uКЭ= ЕКЭ-IК НАС, RК=UКЭ ОСТ. При дальнейшем увеличении тока базы ток коллектора не увеличивается (рисунок 3.16,а) и напряжение на коллекторе не изменяется (рисунок 3.16,б).
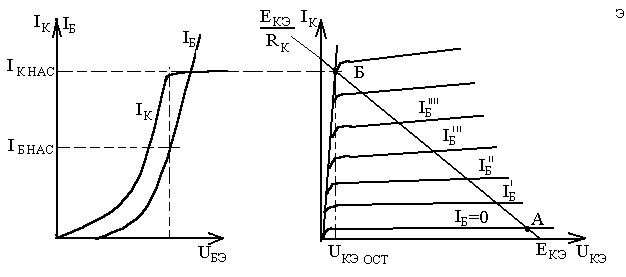
|
а) |
б) |
|
Рисунок 3.16 |
|
3.8.3. Переходные процессы при переключении транзистора
При практическом использовании транзистора большое значение имеет скорость переключения, обуславливающая быстродействие аппаратуры. Скорость переключения определяется процессами накопления и рассасывания неравновесного заряда в базе и коллекторе транзистора, эмиттерном и коллекторном переходах.
В эмиттерном и коллекторном переходах находятся нескомпенсированные заряды неподвижных ионизированных атомов примеси - доноров и акцепторов; неравновесный заряд отсечки в базе можно считать равным нулю.
При переходе к режиму насыщения эмиттерный переход открывается, толщина перехода и его нескомпенсированный заряд уменьшаются, происходит как бы разряд ёмкости эмиттерного перехода. В следствии понижения напряжения на коллекторе, уменьшается его толщина и заряд в нем, т.е. происходит разряд ёмкости коллекторного перехода, открывается коллекторный переход и в области базы за счет инжекции электронов из эмиттерного и коллекторного переходах накапливается большой неравновесный заряд насыщения. В транзисторах, имеющих высокоомный коллектор носители заряда инжектируют и в область коллектора, где так же накапливается неравновесный заряд.
Графики напряжений и токов транзистора при переключении даны на рисунке 3.17. На базу транзистора подается прямоугольный импульс напряжения UВХ-EБЭ (рисунок 3.17,а).
График входного тока показан на рисунке 3.17,б. Величина импульса прямого тока базы IБ ПР определяется в основном сопротивлением ограничительного резистора RБ.
После переключения эмиттерного перехода на обратное направление ток перехода, как и в диоде, имеет первоначально большую величину, ограниченную лишь сопротивлением RБ: IБ ОБР= EБ/ RБ, так как сопротивление эмиттерного перехода в первый момент после переключения очень мало вследствие насыщения базы неравновесными носителями заряда (рисунок 3.17,г).
При прямоугольной форме импульса входного тока импульс выходного тока iК (рисунок 3.17,в) появляется с задержкой tЗ, которая определяется главным образом скоростью нарастания напряжения эмиттерного перехода, зависящей от величин ёмкости перехода и прямого тока базы, т.е. скоростью разряда эмиттерного перехода.
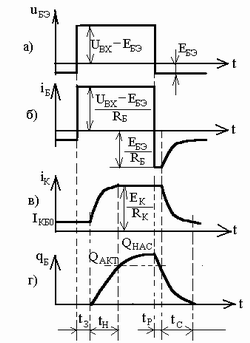
После того как транзистор перейдет из режима отсечки в активный режим, коллекторный ток начинает постепенно нарастать, достигая установившегося значения а время tн. Это время определяется скоростью накопления неравновесного заряда в базе и скоростью разряда емкости коллектора. Таким образом, полное время включения транзистора состоит из времени задержки и времени нарастания:
![]() .
.
Практически оно может иметь величину от нескольких наносекунд до нескольких микросекунд в зависимости от параметров транзистора.
После подачи в цепь базы запирающего тока IБ ОБР=EБЭ/RБ выходной коллекторный ток прекращается не сразу. На протяжении некоторого времени рассасывания tp он практически сохраняет свою величину, так как концентрация носителей заряда в базе у коллекторного перехода еще остается выше равновесной и коллекторный переход благодаря этому оказывается открытым.
Лишь после того как неравновесный заряд у коллекторного перехода рассосется за счет ухода электронов из базы и рекомбинации, ток коллектора начинает постепенно спадать, достигая время спада tС установившегося значения IKЭ0. В течении этого времени продолжается рассасывание неравновесного заряда базы и происходит перезаряд емкости коллекторного перехода. Заметим, что эмиттерный переход при этом может закрыться раньше или позже коллекторного в зависимости от скорости рассасывания неравновесного заряда, сосредоточенного поблизости от него.
Процесс накопления и рассасывания неравновесного заряда qБ при переключении транзистора поясняется на рисунке 3.17,г. Накопление неравновесного заряда в базе начинается спустя время задержки tз, и заряд за время нарастания tн достигает установившегося значения qБ=Qакт. Далее вследствие падения коллекторного напряжения до величины UКЭ ОСТ< UБЭ коллекторный переход открывается и начинает инжектировать неравновесные носители заряда в базу. Заряд базы снова возрастает, достигая к концу входного импульса значения qБ=Qнас. После переключения напряжения эмиттерного перехода на обратное происходит рассасывание неравновесного заряда базы, за время tР+tС он достигает нулевого значения.

